来源: 疾锋劲草,作者:风生水起
拿到一个ST的宣传材料,该资料介绍了Si/SiC混合功率器件可能是过渡到全SiC的中间方案,也找了文章了解了一下原理。资料有限,标题的问题没找到答案。有哪位大神愿意分享一下呢?
大概会分三个部分:
1、ST资料;
2、介绍一篇器件测试的论文;
3、介绍一篇综述文章;
一、ST宣传资料
1、结论
SiC基逆变器的系统成本效益随着电池技术的发展而不断提高
逆变器受益于下一代IGBT和SiC MOSFET的组合,这种混合开关优化了逆变器的性能和成本,优化的成本可能使SiC的新应用成为可能
混合开关需要专用的栅极驱动器,ST正在栅极驱动器和功率晶体管的各个层面进行创新,以引领逆变器设计的这一新趋势
2、内容

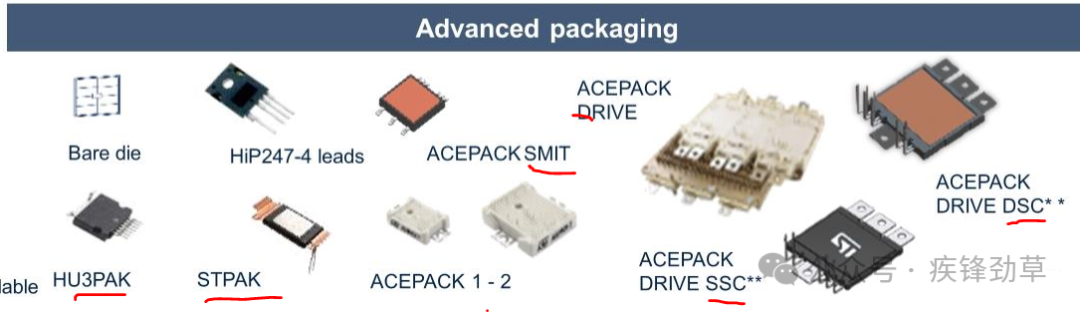

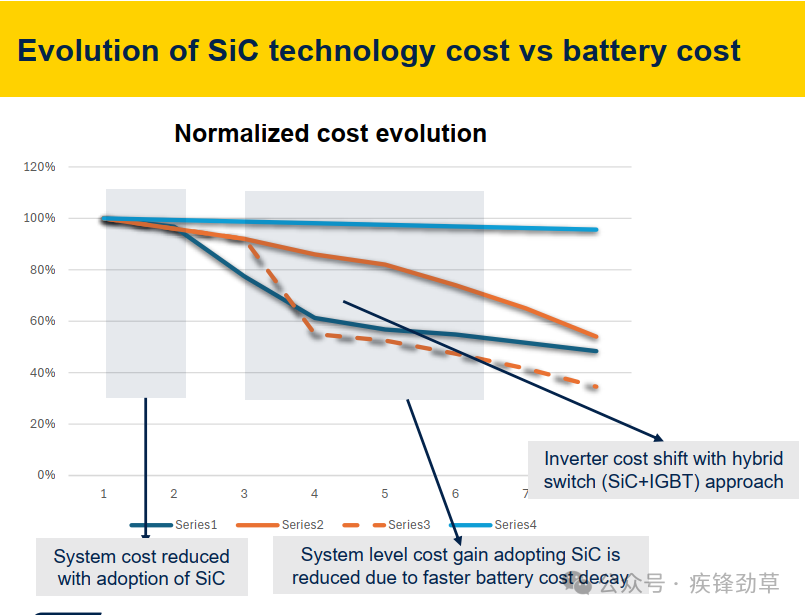
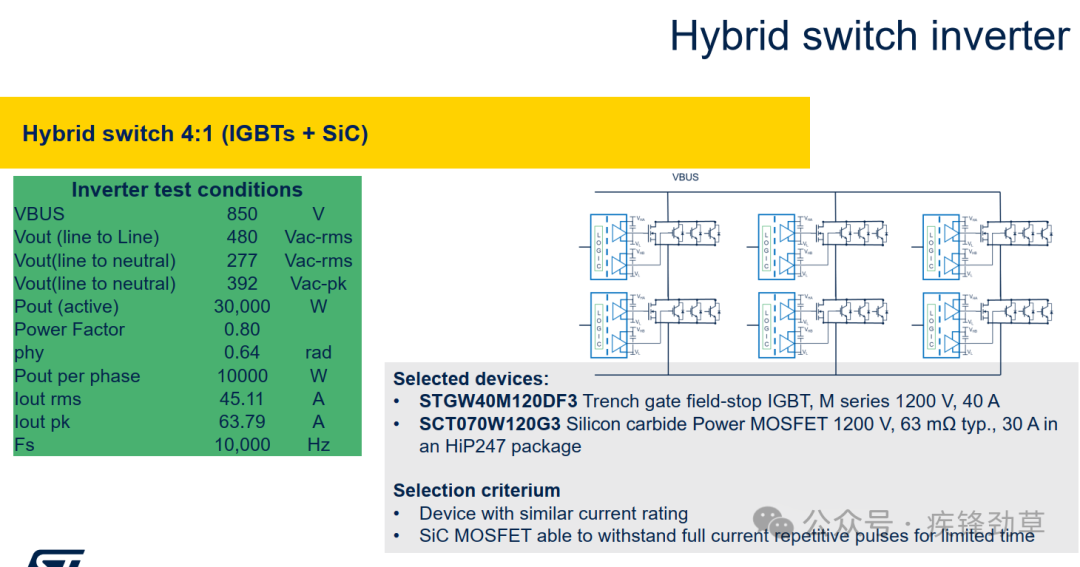
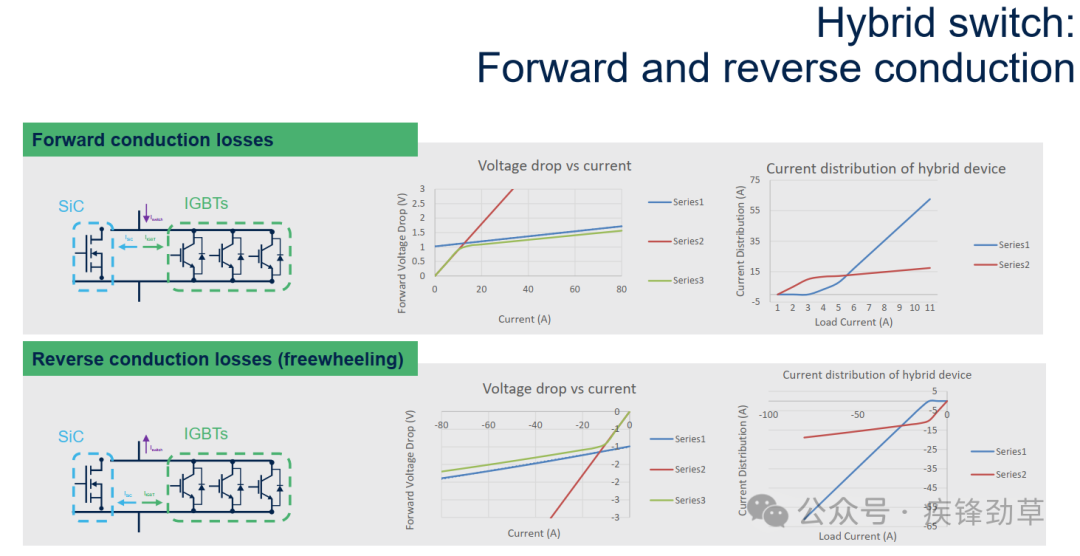

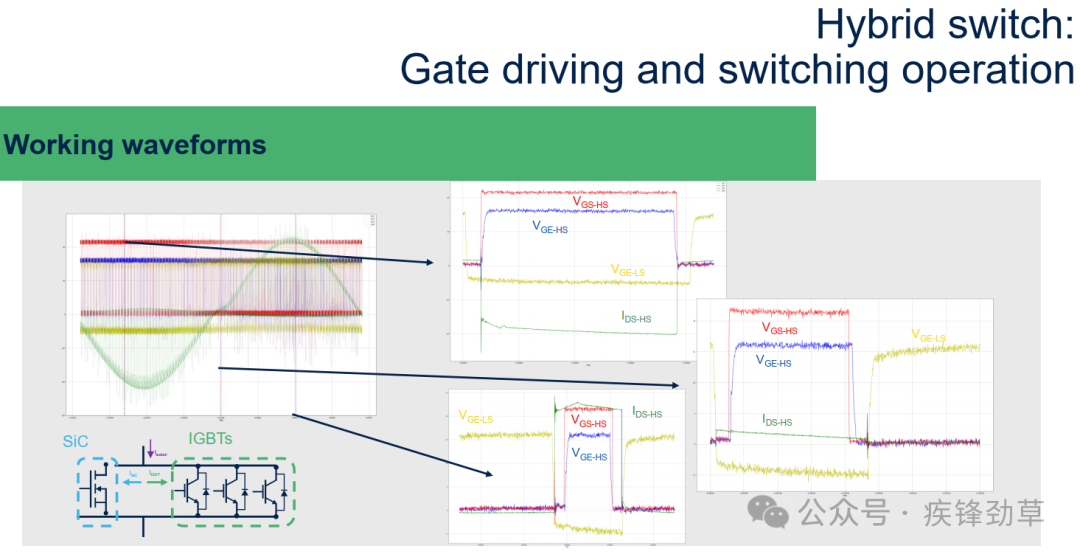

二、混合开关测试论文
High Voltage Si/SiC Hybrid Switch: An Ideal Next Step for SiC
1、介绍
SiC等高压宽带隙半导体的发展因其相对于Si的固有材料优势而受到广泛关注。MOSFET或JFET等SiC功率开关显示出比Si IGBT等硅功率器件明显更好的特性,特别是在显著降低开关损耗方面。大规模采用SiC功率器件面临的一个主要问题仍然是更高的材料和制造成本。此外,高压MOSFET的一个固有缺点是高导通损耗,即使对于SiC MOSFET也是如此。在高压和高温下尤其如此。相反,IGBT最为人所知的是,由于强电导率调制,其正向电压降较低,但在关断期间,电流尾部会导致更高的关断损耗。因此,提出了通过并联连接IGBT和MOSFET来结合MOSFET和IGBT优点的混合MOSFET和IGBT开关。然而,迄今为止提出的混合开关都是用于低压应用的,IGBT和MOSFET都是硅器件。本文是高压Si/SiC混合功率模块的第一项已知工作,该模块集成了并联的高压SiC MOSFET和Si IGBT,如图1所示。本文讨论了Si/SiC混合开关在SiC MOSFET和Si IGBT上的优越性能及其可负担的成本,以证明这一有前景的概念是SiC的理想下一步。
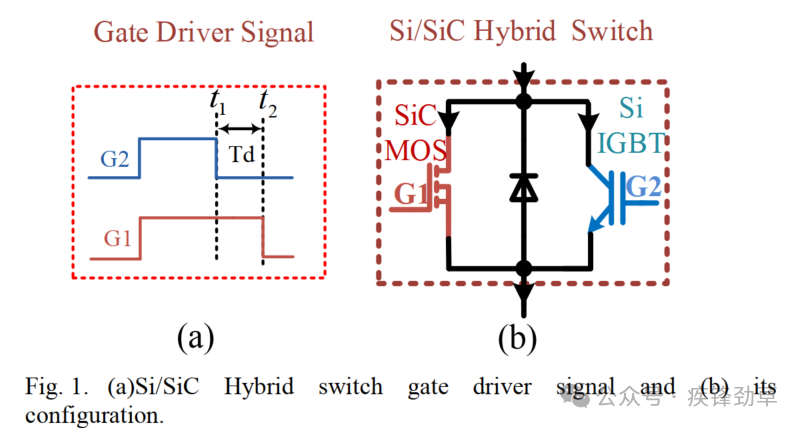
2、Si/SiC混合开关的配置与操作
Si/SiC混合开关的配置
图1显示了所提出的Si/SiC混合开关及其栅极驱动信号,该开关集成了并联的高压SiC MOSFET和Si IGBT。众所周知,IGBT等双极半导体器件在高电流密度下具有更好的正向导通特性(如图2所示),MOSFET等单极半导体器件具有更快的开关速度和更低的开关损耗,尤其是关断损耗。因此,为了结合IGBT和MOSFET的优点,首先关闭Si IGBT,所有电流将换向到SiC MOSFET,然后在精心设计的延迟时间Td后关闭SiC MOSFET。这样,利用IGBT的低导通损耗能力,通过混合开关实现了低正向导通压降。由于SiC MOSFET的超低关断损耗,开关损耗将显著降低。该概念也适用于SiC JFET。由于缺乏6.5 kV SiC器件样品,本文中给出的结果是使用Cree的10kV/10A SiC MOSFET(芯片面积=0.48cm2)原型和ABB的商用6.5kV/25A Si IGBT(芯片面积=1.84cm2)获得的。
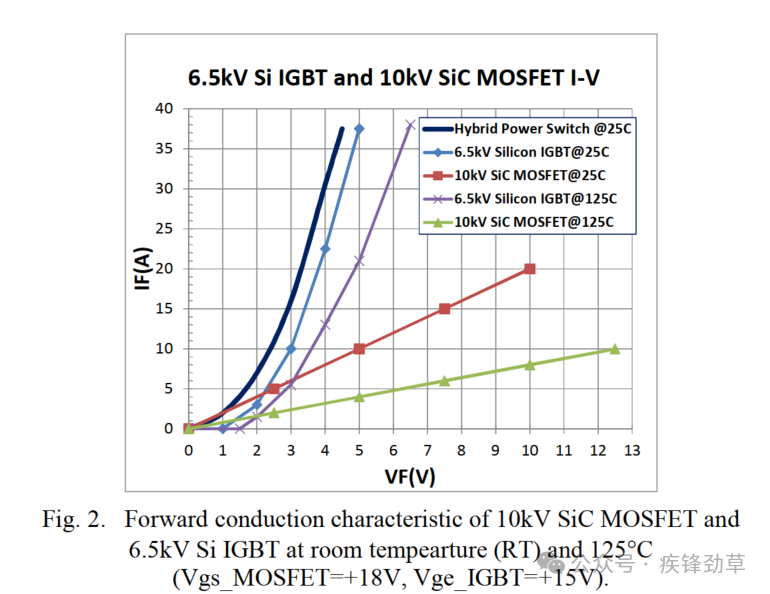
正向特性比较
6.5kV Si IGBT和10kV SiC MOSFET分别在25°C和125°C下的I-V曲线如图2所示。在较低电流(~5A)下,10kV SiC MOSFET显示出更好的正向导通特性,而在20A或更高的高电流下,Si IGBT在正向导通方面具有压倒性的优势。这在更高的温度下更为明显。混合开关在25°C下的IV曲线也如图2所示。可以发现,混合开关结合了Si IGBT在高电流下和SiC MOSFET在低电流下的优点。正向传导特性甚至比Si IGBT更好,因为SiC MOSFET也传导总电流的一部分。
关断延迟时间分析
混合开关的一个主要挑战是确定适当的SiC MOSFET关断延迟时间Td,如图1所示。在图3中,Si IGBT关断损耗Eoff分别被分析为4kV、20A和30A下Td的函数。可以发现,IGBT的Eoff随着Td的增加而减小。在前10us,Eoff的减小速度比Td=10us后快约2倍。当Td为20us时,与不添加Td的情况相比,可以实现约70%的IGBT关断损耗降低。可以选择10us MOSFET关断延迟作为开关频率和关断损耗降低之间的折衷。
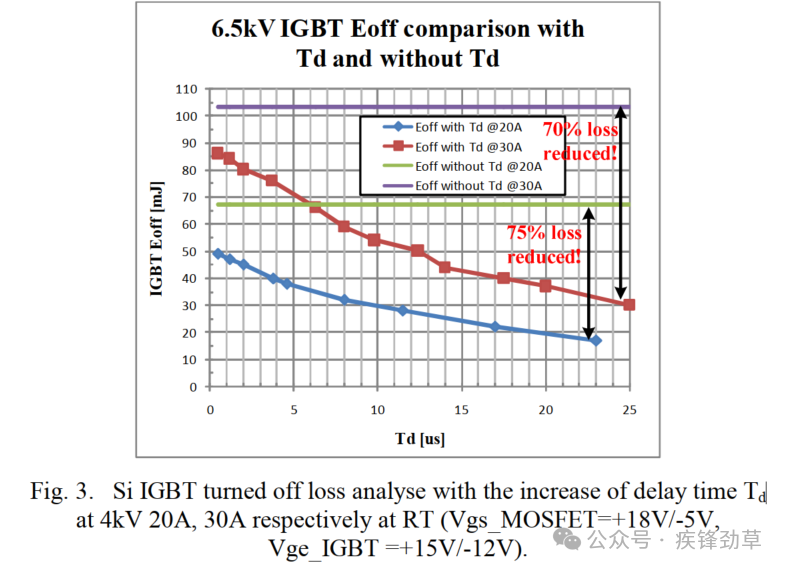
混合开关背后的原理
如图1(a)所示,所提出的开关损耗改善背后的物理原理是IGBT分别在t1的ZVS关断和t2的ZCS关断下运行。在t1,IGBT的栅极电压被去除,IGBT中的MOSFET沟道将被快速去除。同时,电流被换向到SiC MOSFET。开放式基极中储存的过量少数载流子将根据双极/或少数载流子的寿命逐渐衰变。在此期间(从t1到t2),IGBT上的电压被MOSFET的低正向电压降箝位,该电压降几乎为零。因此,硅IGBT可以实现ZVS关断。在Td期间,IGBT和MOSFET都施加了低电压降,由于少数载流子复合,N基极区中的大量存储电荷呈指数级下降。在t2,混合开关中的SiC MOSFET被关断。如果延迟时间Td设置得足够长,则在t2留下的存储电荷很少。当Si IGBT上的电压由于SiC MOSFET关断而增加时,只有很小的电流会通过Si IGBT为其寄生电容器充电。实现了硅IGBT的ZCS关断。
图3显示,被测IGBT中的载流子寿命相对较高。然而,详细分析还表明,基于exp(-t/?hl)的模型不是Eoff估计的准确模型,因为损耗与t2时ZCS关断期间的动态有关,其中dV/dt由MOSFET强烈决定。留在IGBT中的载流子必须支持高dV/dt,因此通常会再次发生更高的载流子提取率,导致更高的IGBT电流,从而导致IGBT损耗。由于IGBT处于开基PNP模式,因此该电流还会引起额外的载流子注入,这将进一步增加IGBT损耗,或者ZCS模式下IGBT损耗的降低没有模型exp(-t/?hl)预测的那么低。
3、Si/SiC混合开关损耗减少分析
Si/SiC混合开关单脉冲测试
为了评估混合开关的关断损耗改善情况,如图4所示,开发了一种单脉冲测试仪,包括高压直流电源、直流电容器和箝位电感负载。在单脉冲测试仪中测量了硅IGBT和混合开关的关断损耗,将在图6和图7中进行比较。
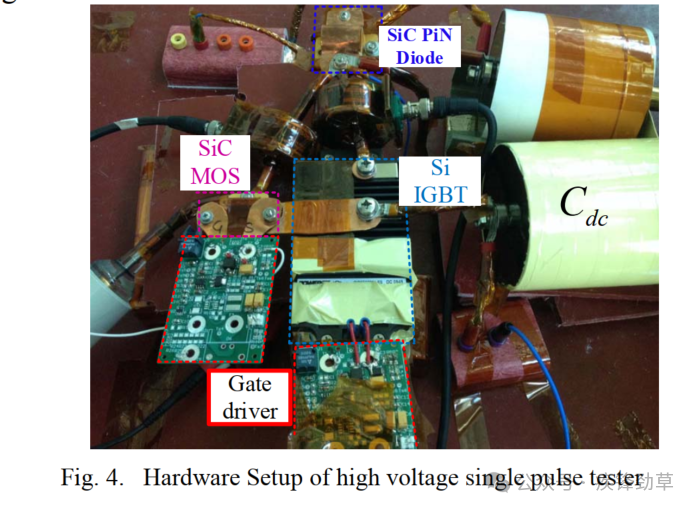
图5显示了混合开关的单脉冲测试波形。首先,SiC MOSFET和Si IGBT同时导通。由于SiC MOSFET在较低电流下的电压降较低,几乎所有的电流都通过SiC MOSFET。随着总电流的增加,总电流的更大一部分通过Si IGBT。可以看出,在高电流下,大部分电流通过Si IGBT,通过SiC MOSFET Ids的电流几乎保持不变。在关断状态下,SiC MOSFET在Si IGBT之后10us关断。
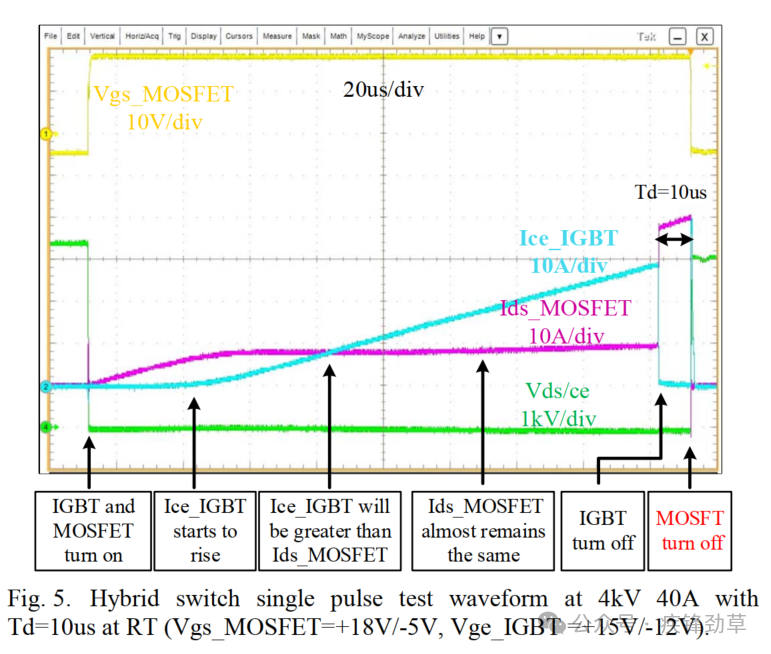
关断损耗比较
图6显示了标准硅IGBT关断波形。Si IGBT在4kV、40A下的关断损耗约为139mJ,电流变为零大约需要2us。从同一测试仪上获得的SiC MOSFET在4kV、40A下的关断损耗仅为20mJ。
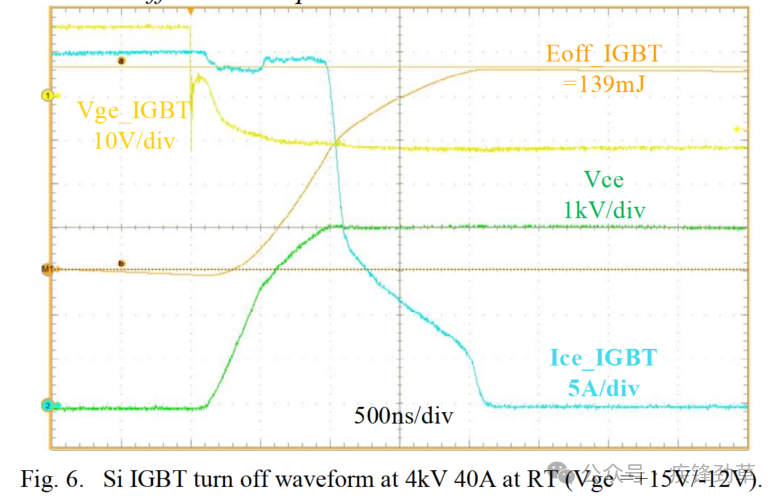
图7显示了混合开关在时刻t2的关断波形。混合开关的总关断损耗由两部分组成,一部分是Si IGBT关断损耗,为78mJ,另一部分是SiC MOSFET关断损耗。因此,混合开关的总关断损耗约为79mJ,与标准IGBT关断相比,损耗降低了近44%。在MOSFET关断后的快速电压上升阶段,Si IGBT中仍有大量电荷残留,导致关断损耗显著降低,但仍然很高。在这个测试案例中,dV/dt仍然主要由IGBT而不是MOSFET决定,因此MOSFET损耗为1 mJ,而不是独立MOSFET条件下的20 mJ。随着延迟时间Td的延长,混合开关的关断损耗将进一步降低。实验发现,Si IGBT的开关损耗在高温下比室温下高出约3倍,而正向特性可以保持在较低水平。相比之下, SiC MOSFET在高温下的Ron大约是室温下的2倍,而开关损耗几乎保持不变。因此,可以预期,在高温下,Si/SiC混合开关可以实现更大的损耗降低。
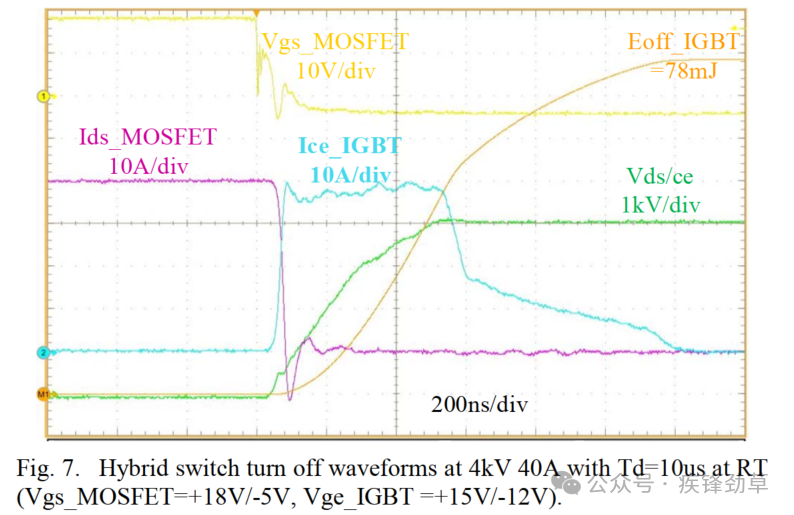
基于Si/SiC混合开关的逆变器损耗分析
为了评估Si/SiC混合开关的损耗改善,以100kW-200kW转换器为例,假设其开关频率为2kHz,占空比为50%。
图8分别显示了混合开关、SiC MOSFET和Si IGBT在4kV 20A、30A和40A下的正向传导损耗比较。可以发现,混合开关和硅IGBT的导通损耗几乎相同。SiC MOSFET由于其在高电流密度下的高Ron而具有最高的导通损耗,并且随着电流的增加,间隙变宽。
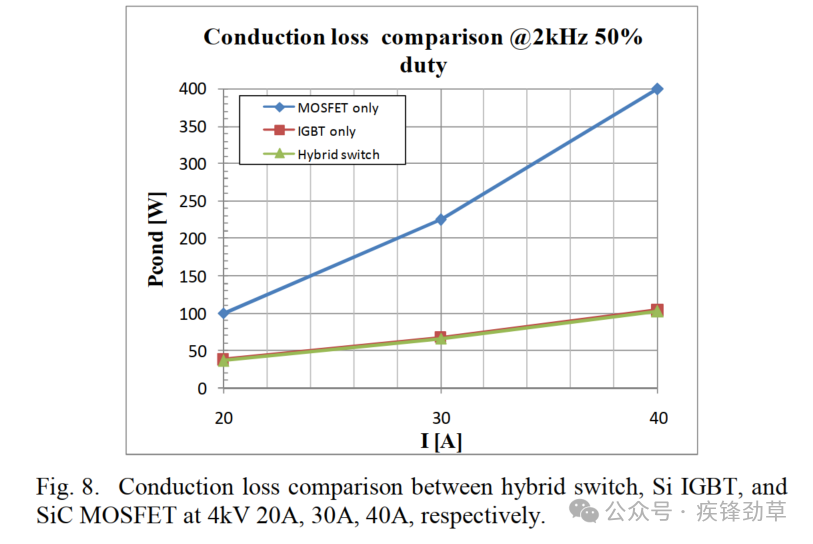
图9分别给出了三种器件在4kV 20A、30A和40A下的关断损耗比较。SiC MOSFET由于其快速的开关速度而具有最低的关断损耗,而Si IGBT具有最高的关断损失。由于SiC MOSFET在关断状态下的帮助,混合开关的关断损耗比Si IGBT低约50%。

图10分析了包括传导损耗和关断损耗在内的总损耗。与Si IGBT和SiC MOSFT相比,所提出的混合开关的总损耗降低了约35%。随着电流的增加,优势也在扩大。总之,混合开关在降低损耗方面表现出了优越的性能,特别是在高功率应用中。
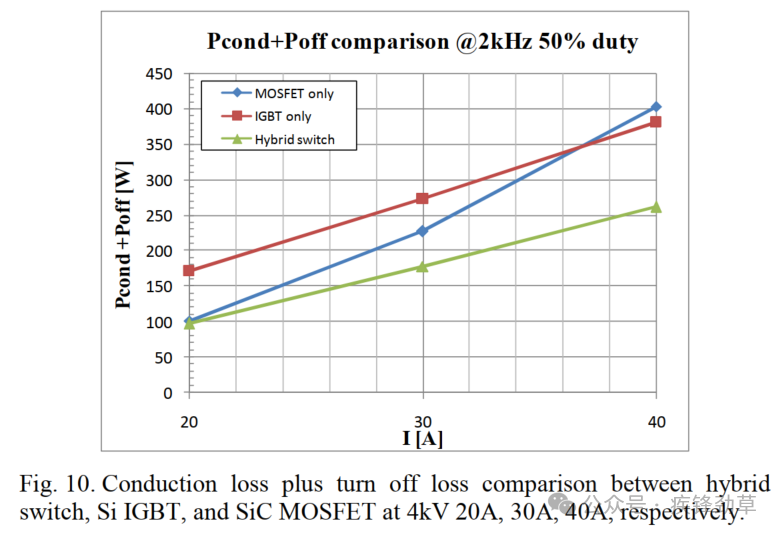
4、混合开关的成本分析
Si/SiC混合开关的成本由SiC器件与Si器件的成本比以及Si IGBT和SiC MOSFET之间的电流分布决定,如图11所示。例如,当SiC器件的每安培成本是Si器件的4倍(SiC/Si成本比为4),Si IGBT的额定电流是SiC MOSFET的额定电流的5倍(Si/SiC电流比为5)时,与Si IGBT相比,实现高达70%的关断损耗降低只需要50%的额外成本。成本分析表明,成本增长非常温和,同时实现了显著的损失减少。较高的Si/SiC电流比意味着所需的成本增加更小。然而,Si/SiC电流比不能无限增加,因为这受到MOSFET安全工作区域的限制。SiC MOSFET需要大的关断能力,这将是我们未来研究和分析的一部分。
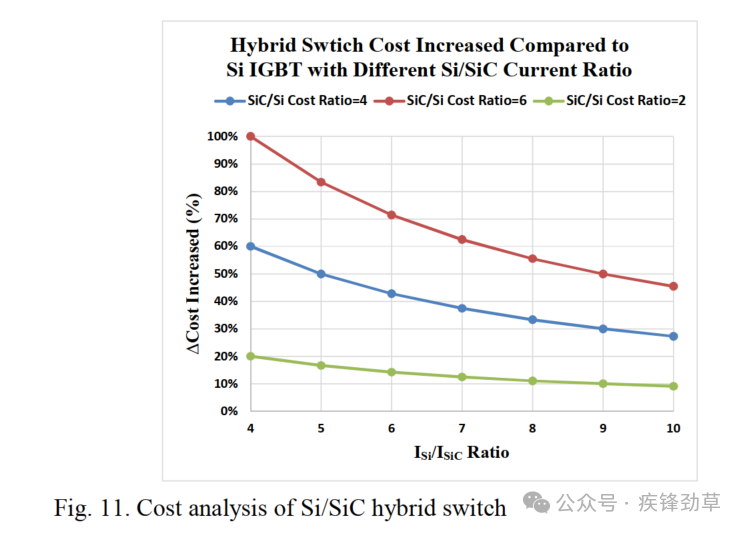
5、总结
本文提出了一种高压Si/SiC混合开关概念,作为SiC器件的自然理想下一步。与硅IGBT相比,Si/SiC混合开关的优越性能和可负担的成本表明了其在高压应用中的前景。未来,Si/SiC混合开关的导通过程将做更多的工作。此外,对SiC和Si器件芯片尺寸优化的更多研究可以进一步降低Si/SiC混合开关的成本。
三、综述
《基于 Si IGBT / SiC MOSFET 的混合开关器件综述 》,这篇是中文的,看起来比较方便。如下
1、介绍
近年来,由于碳化硅( SiC) 器件具有优异的性能,如单位导通电阻小、可高频开关、可高温运行、耐压高、抗辐射等优点,成为电力电子界重点研究的方向之一,具有广阔的应用前景[1,2] 。世界各国都在努力开发 SiC 器件,并希望能够尽快应用到各行业的变频器中,早日替代现有硅器件。
然而,受到 SiC 晶圆生长工艺和芯片加工能力限制,当前 SiC MOSFET 的单芯片载流能力远低于Si IGBT[3] 。
制约芯片载流能力的另一因素是成本,提高芯片面积是提高载流能力主要方法。 现阶段 SiC 衬底普遍存在缺陷,强行增大芯片面积会导致成品率大
幅下降、价格飙升[5] 。
面对大电流应用的需求,为解决这一问题,SiC /Si 混合器件开始出现。 最初是简单的 SiC Diode / Si IGBT 混合方法,并不能充分发挥 SiC 的优势,还可能带来剧烈的开关振荡[10] 。 近年来,各国研究人员不断开展 SiC MOSFET / Si IGBT 混合开关器件( Hybird Switch,HyS) 的研究[8-29] ,能够实现 IGBT 的零电压开通和关断,有效结合 SiC MOSFET 的低开关损耗优点和 Si IGBT 大载流能力优点,各器件损耗比较如图 1 所示,与纯 SiC 器件相比成本也会大幅下降,特别适合用于同时需求大电流、高开关频率、高功率密度的车用电机控制器、大功率无线充电、多电化飞机和电力电子变压器等应用[7] 。

本文综述了基于 Si IGBT / SiC MOSFET 的混合开关器件,分析了相关的门极驱动时序、门极驱动硬件设计、电流分配优化、功率模块设计、变频器设计和成本分析等设计要点。
2、 门极驱动时序
在常规的混合开关器件驱动时序中,为了降低开关损耗,实现 Si IGBT 的零电压( ZVS) 开通和零电压关断,需要在 Si IGBT 开通前开通 SiC MOSFET,在 Si IGBT 关断后关断 SiC MOSFET。常见的 4 种门极驱动时序如图 2 所示,时序 1是理想器件的驱动时序,Si IGBT 和 SiC MOSFET 的开关时序与门极驱动时序相同。
一般情况下 SiCMOSFET 的门极电容远小于 Si IGBT,开关延时也很小,门极驱动采用时序 2 可以达到与时序 1 类似的开关效果,但可以简化电路。 如果 HyS 由独立器件组成,回路中将存在较大的寄生阻抗,Si IGBT 的开关过程将有较大的延迟,门极驱动可采用时序 3 实现 ZVS,能够减小 SiC MOSFET 独立开通载流的时 间。
一些门极硬件设计不能很好地抑制 Si IGBT 的米勒(Miller)效应,需要采用时序 4 驱动防止 Si IGBT 误导通,这种方法会带来较大的损耗,有违 HyS的设计初衷。
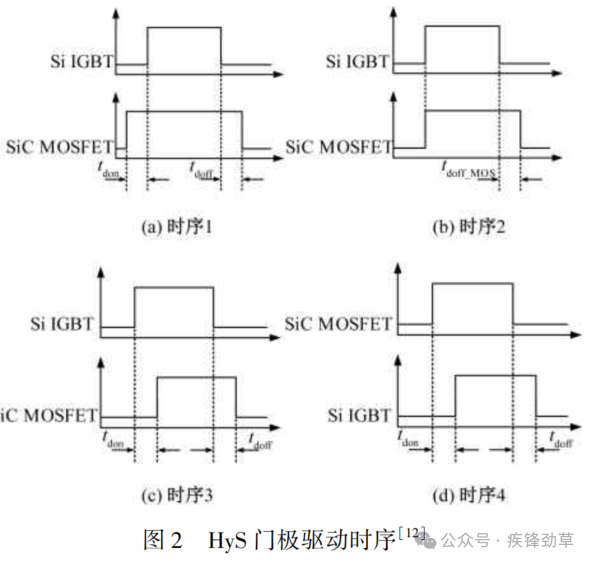
参考文献[27]给出了另一种驱动时序,通过降低 SiC / Si 配比来降低成本,如图 3 所示。 在这种时序中,SiC MOSFET 先于 Si IGBT 开通,在 Si IGBT 开通后立刻关断,并于 Si IGBT 关断前再次开通,在 Si IGBT 关断后再次关断。
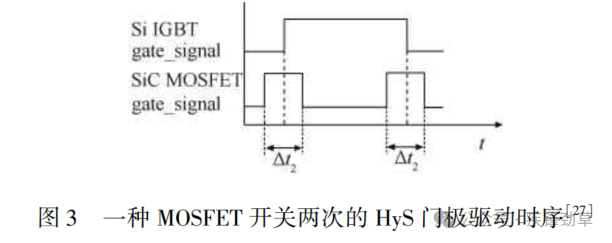
图 3 中 SiC MOSFET 只在 HyS 开关瞬态时间内处于导通状态,降低了 SiC MOSFET 的导通损耗。然而,这些损耗完全转移到 Si IGBT 上,多出的两次开关动作及由此导致的换流过程会引起总损耗的增加,与时序 1 相比其效果较差,还会引起稳定性问题 。
3、 门极驱动硬件设计
在文献[8-17]所示的 HyS 关断过程中,可以明显地观察到米勒效应。 这是由 SiC MOSFET 的高速关断引起的,较大的 dv / dt 将在已关断的 Si IGBT 门极回路上引起较大干扰,感生的米勒电流通过 Si IGBT 门极阻抗出现电压尖峰,当尖峰超过门极电压阈值时 Si IGBT 会再次导通。
米勒效应将影响 Si IGBT 的 ZVS 过程,虽然HyS 的拖尾电流时间短于纯 Si IGBT 器件,关断时间和关断损耗却远大于纯 SiC MOSFET 器件。 特别对于由独立器件组成的 HyS,较大的寄生阻抗将使这一现象更为恶劣,有些研究者使用图 2 中的时序4,但会带来较大损耗。
文献[11] 采用负电压来抑制米勒现象,但在HyS 中 Si IGBT 的发射极和 SiC MOSFET 的源极连在一起。 - 5 V 是常规 SiC MOSFET 产品使用的合理负压值,但仍不能够完全抑制米勒现象。
文献[19]采用带有米勒钳位功能的门极驱动芯片 ACPL-332J 来改进硬件电路,实现了较好的效果,带有米勒钳位的门极驱动电路如图 4 所示。 该芯片内部具有米勒钳位功能,能够在 Si IGBT 关断的情况下降低门极回路阻抗,降低感生电压峰值,从而抑制米勒现象。
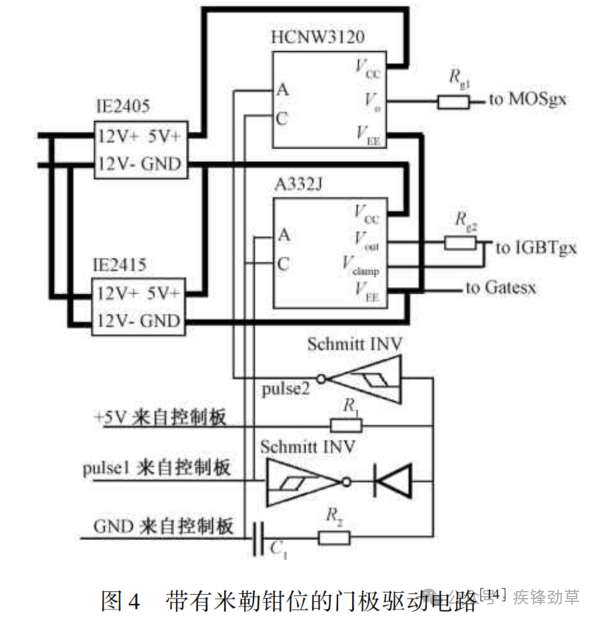
为降低驱动复杂度,该电路对于 SiC MOSFET使用简单的 HCNW3120 进行驱动。 文献[19 ] 将该电路用于一款 1200V / 200A HyS 模块的驱动,在600V / 200A 下的双脉冲实验关断波形如图 5 所示。
图 5 中使用了带有米勒钳位的驱动芯片后,HyS 实现了快速关断,没有明显的拖尾电流,更接近纯 SiC 器件。 与不使用米勒钳位芯片的驱动电路相比,其瞬态特性见表 1:
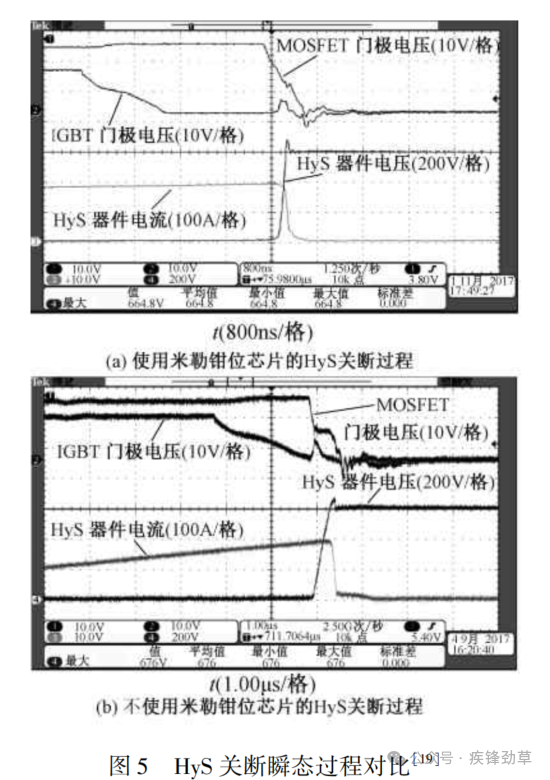

文献[11]讨论了门极驱动与器件短路耐量的关系。 如果降低 MOSFET 的驱动电压,HyS 的整体短路耐量将有所改进,但损耗会大幅增加。
4、 电流分配优化和 HyS 模块设计
HyS 器件内部电流分配优化过程中经常使用SiC / Si 配比参数,低配比能降低 SiC MOSFET 芯片的载流压力和散热压力,也能降低 HyS 的整体成本。
文献[18]基于已商业化的 Si IGBT 和 SiC MOSFET 独立器件对 1. 2kV 的 HyS 进行了较为系统的配比优化,得到了 1∶ 4和 1∶ 6的低配比方案。 在优化过程中主要比较了器件的结温,采用仿真和等效网络等方法估算相关结温。 但 50A 的 SiC MOSET 芯片只 能 在 短 时 间 内 支 撑 300A 运 行, 难 以 超 过500ns,相关优化应该注意与门极驱动的时序结合。
文献[14]给出了 HyS 模块电流分配方案的优化过程,该过程评估每种方案的损耗和芯片结温。由于 HyS 模块多使用产品化 Si IGBT 芯片和 SiC MOSFET 芯片,计算并不复杂。与独立器件相比,功率模块可有效降低杂散损耗,也能够带来更好的散热。 特别对于超过 30kW的中、大功率应用,在功率模块内部实现多芯片的并联,其效果要好于通过母排并联多个独立器件。
文献[19]给出了 HyS 功率模块设计要点和案例,实现了一款 1200V / 200A 模块的布局优化。 该模块是桥臂模块,每个桥臂由 1 个 50A SiC MOSFET 芯片、2 个 100A Si IGBT 芯片、1 个 150A Si Diode 组成。为降低门极回路阻抗,预留了 kelvin 门极端子。受 Si 芯片限制,该模块的设计目标为支持芯片结温 175°C,首先选取了有关的封装材料,具体见表2。 为了进一步降低寄生阻抗,该模块使用超声波焊接技术连接 DBC 与功率端子和信号端子。
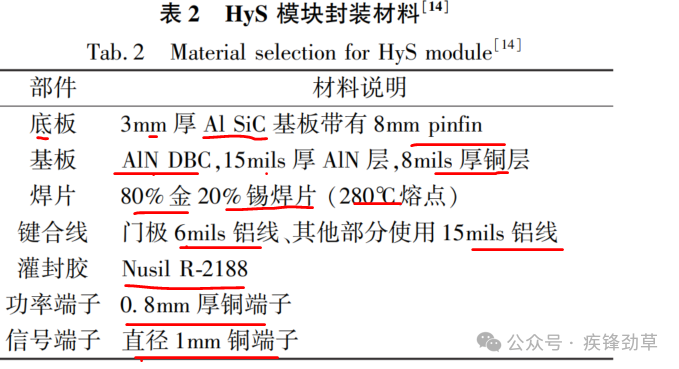
在模块设计阶段,采用了基于遗传算法的自动布局优化方法,对设计空间进行有向性搜索,充分考虑了寄生电感、并联芯片的均流、体积、散热、门极信号与主回路的解耦。 最终布局的图案如图 6 所示,
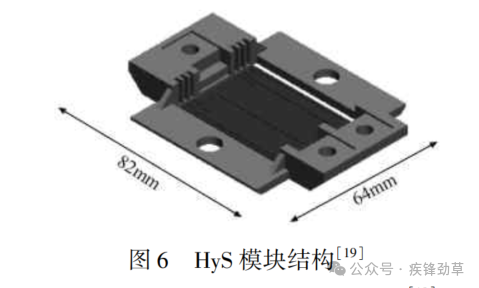
模块样件如图 7 所示。

为了验证布局优化结果,作者采用有限元软件Q3D 抽取了杂散电感,杂散电感如图 8 所示,并采用双脉冲测试的方法检测了模块的开关特性,其结果与设计一致。 该模块用于本文第 5 节的 3. 4kW无线充电变频器。
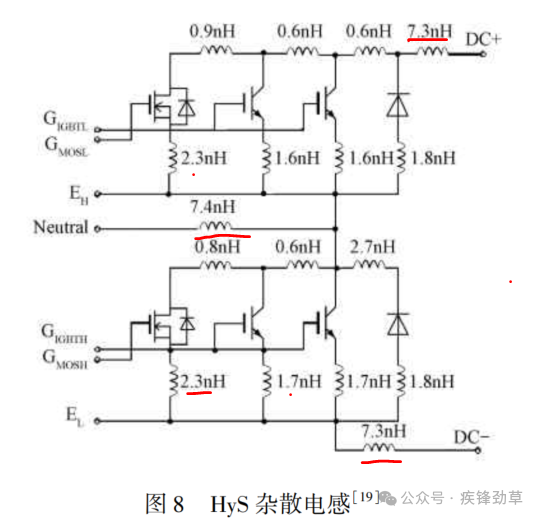
除了设计开发混合开关模块,还可利用现有的SiC MOSFET 模块或 Si IGBT 模块,用母排进行器件间的连接[15,29] 。 此方法需要良好的母排设计才能尽可能降低相关寄生阻抗,散热设计也需兼顾不同器件间的平衡。 图 9 给出了 IGBT 模块与 MOSEFT独立器件的配合案例,图 10 给出了 SiC MOSFET 模块与 Si IGBT 模块的配合案例,具体的母排设计细节和连接方法可以参考文献[15]和文献[29]。
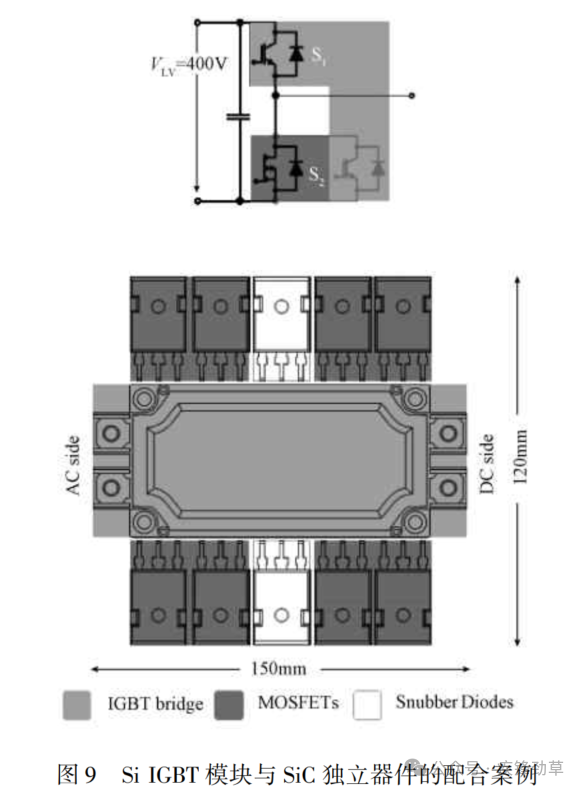
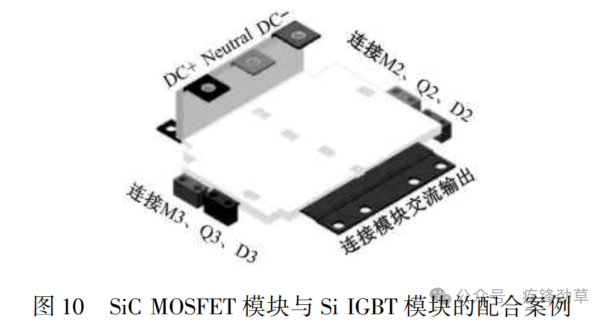
对于高压 HyS 器件来说功率模块是必不可少的,高压模块的应用对象功率普遍较大,还需要考虑局部放电、散热等一系列问题,很难用独立器件完成。 图 11 和图 12 分别给出了 3. 3kV HyS 模块和6. 5kV HyS 模块的布局案例[20,22] 。 这些文献还验证了高压 HyS 的高速开关特性,有望用于未来电网。 因为高压芯片的电流普遍较小,普遍需要大数量芯片并联才能达到所需要的电流,其特性有待进一步验证。
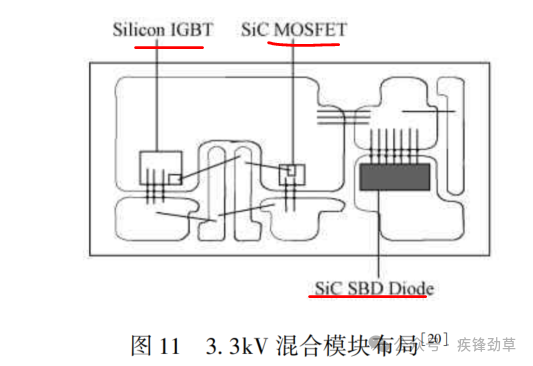
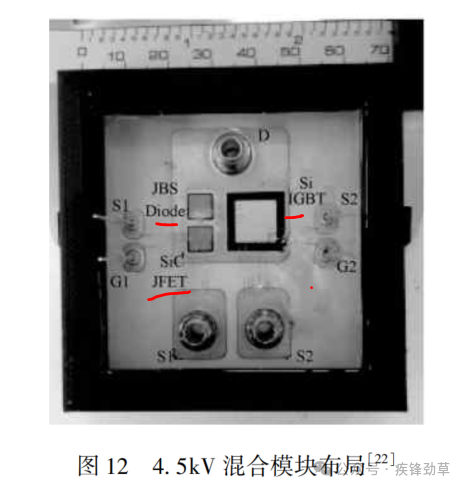
5、 基于 HyS 的变频器
迄今为止基于 HyS 的变频器还处于研究阶段,尚无小规模示范应用。 受到独立器件限制,很多文 献只对 HyS 器件进行了双脉冲实验。 相对于纯 Si
变频器或纯 SiC 变频器,HyS 变频器系统复杂度较高,本节对相关文献工作总结如下。第一例是 3. 4kW 无线充电用逆变器,如图 13所示,详细的设计和测试可参考文献[23]。
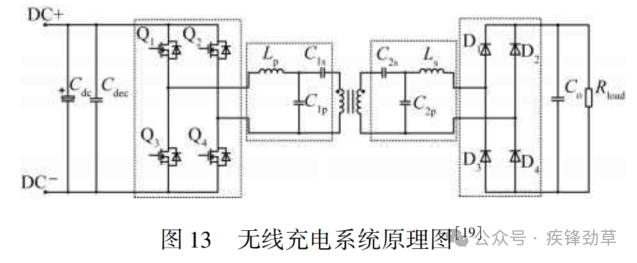
该系统使用 2 个 HyS 桥臂模块实现 H 桥拓扑,运行于 50kHz,峰值功率达到 3. 4kW,部分波形如图14 所示。 在测试中 Si IGBT 良好地实现了 ZVS,系统损耗较低。
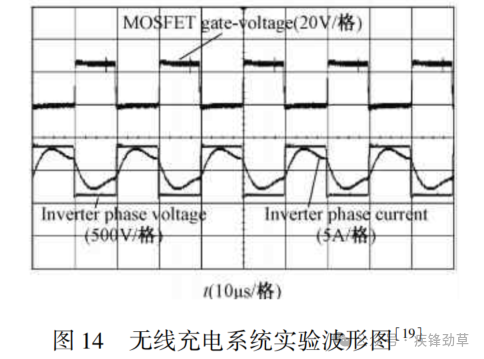
第二例使用独立器件搭建了 Boost 变频器[18] ,如图 15 所示。 该系统使用 650V 的 SiC MOSFET 和 Si IGBT 实现了 1∶ 5的电流配比,运行于 20kHz。 该文献 还对 HyS 变频器的电磁兼容特性进行了测试和分析。
相关电磁兼容的研究可进一步参考文献[23]。
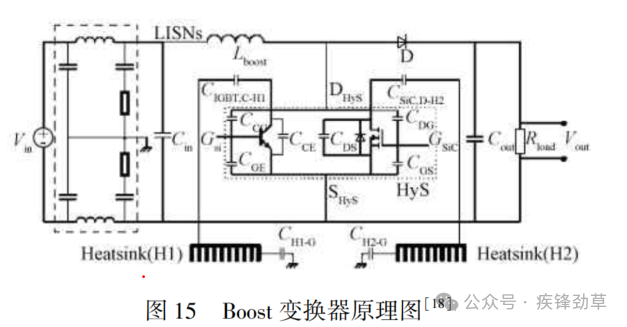
第三例是采用强制风冷的三相逆变器,由 3 个HyS 桥臂模块组成,实现了 30kHz 开关频率,功率达到 5kW[23] ,如图 16 所示。 在后续的水冷升级版硬件中,该系统达到了 15kW。

第四例采用了三电平 T 型模块,如图 17 所示,由 SiC MOSFET 模块与 Si IGBT 模块配合组成HyS,设计目标是 100kW 的变频器。 文献[17] 中 对 单 相 器 件 进 行 了 测 试, 实 现 了 28kHz 和17. 5kV·A运行。
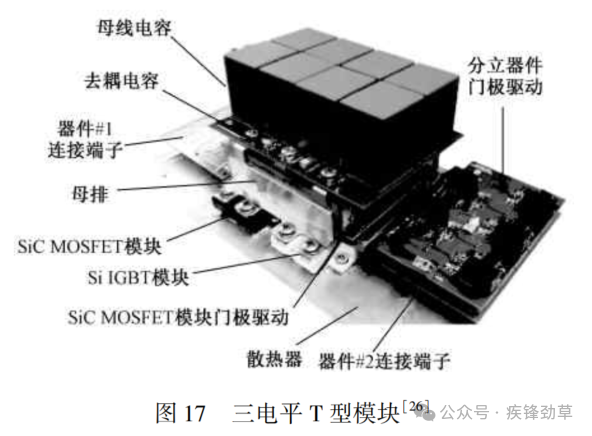
以上几个 HyS 变频器都展示了 SiC / Si 混合开关器件的优异特性,在 SiC 器件产品价格降低到接近 Si 器件之前,该类变频器有一定应用前景,特别是对于同时要求较高开关频率和中、大输出功率的应用。
6 、HyS 的成本分析
相比于纯 SiC 器件,HyS 的最大优势来自成本。这部分数据比较老了,就删掉了。
文献[25] 尝试使用更低的 SiC / Si 配比,达到1∶ 6,使 HyS 器件的成本更接近 Si IGBT 器件。 然而这种配比缺乏相关散热验证,需要进一步验证变频器的性能。
由于 HyS 需要使用更加高性能且复杂的门极驱动芯片,在讨论 HyS 成本问题的时候应该注意包含这一部分。 HyS 所需门极驱动芯片的特点主要包括大驱动电流、高 dv / dt 抑制能力、短时间延迟、具有保护功能、具有米勒钳位功能等,一些常用驱动芯片的价格见表 6。
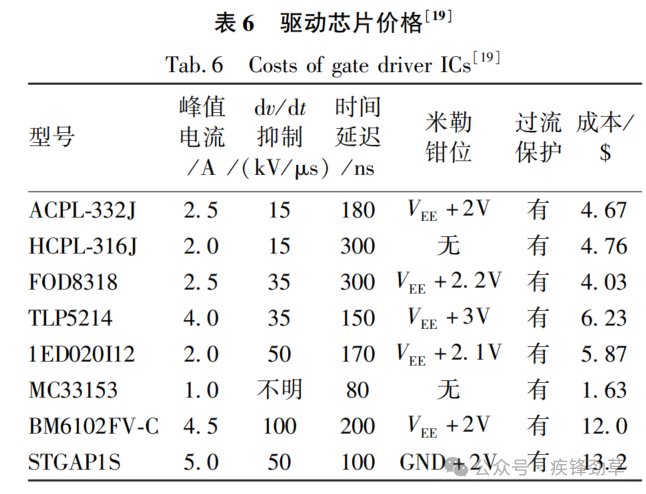
这几年SiC的价格变化比较大,这篇文章是2018年的,不知道当前是个啥进展。还下了一些较新的文章,有时间继续扒。
-
MOSFET
+关注
关注
150文章
8688浏览量
221131 -
逆变器
+关注
关注
294文章
4927浏览量
211387 -
功率器件
+关注
关注
42文章
1947浏览量
92973 -
SiC
+关注
关注
32文章
3239浏览量
65608 -
栅极驱动器
+关注
关注
8文章
1099浏览量
39726
原文标题:Si/SiC混合模块会是好的选择吗?
文章出处:【微信号:芯长征科技,微信公众号:芯长征科技】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
如何混合Si和SiC器件实现完整SiC MOSFET转换器相同效率的调制方案
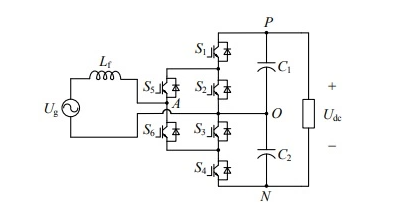
SiC MOSFET 开关模块RC缓冲吸收电路的参数优化设计
为何使用 SiC MOSFET
SiC-MOSFET的应用实例
SiC-MOSFET与Si-MOSFET的区别
Si-MOSFET与IGBT的区别
搭载SiC-MOSFET和SiC-SBD的功率模块
SiC-MOSFET有什么优点
SiC功率器件概述
SiC功率器件SiC-MOSFET的特点
SiC-MOSFET器件结构和特征
SiC MOSFET的器件演变与技术优势
对SiC-MOSFET与IGBT的区别进行介绍
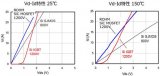





 基于Si IGBT/SiC MOSFET的混合开关器件综述
基于Si IGBT/SiC MOSFET的混合开关器件综述

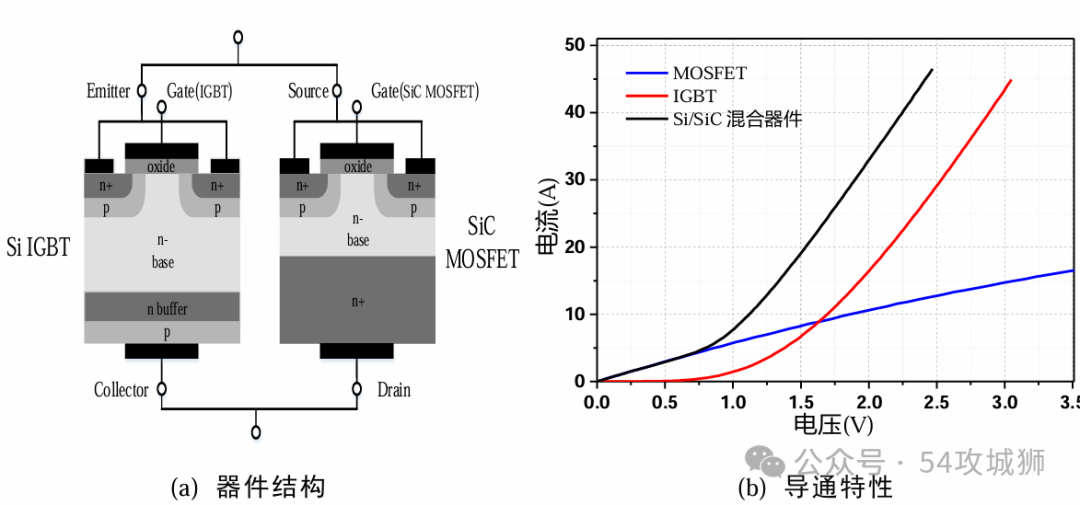











评论