一、引言
在半导体行业中,封装技术对于功率芯片的性能发挥起着至关重要的作用。随着电子技术的飞速发展,特别是在大功率场合下,传统的封装技术已经难以满足日益增长的性能需求。因此,Cu Clip封装技术作为一种新兴的封装方式,逐渐在半导体领域崭露头角。本文将详细探讨Cu Clip封装技术的定义、发展历程、技术特点、优势、应用以及未来的发展趋势。
二、Cu Clip封装技术概述
Cu Clip封装技术,即铜条带或铜片键合技术,是一种采用焊接到焊料的固体铜桥实现芯片和引脚连接的封装工艺。与传统的引线键合技术相比,Cu Clip封装技术通过铜片来连接芯片与管脚,从而在一定程度上取代了标准引线键合方式。这种封装方式不仅具有独特的封装电阻值和更高的电流量,还具备更好的导热性能。
三、Cu Clip封装技术的发展历程
半导体封装技术的发展是一个不断演进的过程。从早期的金线键合,到后来的铝线(带)键合、铜线键合,再到如今的Cu Clip键合,每一种封装技术都代表着半导体行业在追求更高性能、更低成本方面的不断努力。
- 金线键合:作为最早期的封装技术之一,金线键合在半导体封装领域曾占据重要地位。然而,由于其成本较高,逐渐被其他更经济的封装技术所取代。
- 铝线(带)键合:随着电子技术的不断发展,铝线(带)键合技术因其成本较低而被广泛应用于半导体封装领域。然而,在大功率场合下,铝线(带)键合技术面临着高频寄生参数大、散热能力不足、耐温低、绝缘强度不足等问题。
- 铜线键合:为了进一步提升封装性能,铜线键合技术应运而生。与铝线(带)键合相比,铜线键合具有更低的电阻率和更好的导热性能,从而在一定程度上解决了散热能力不足等问题。然而,随着功率芯片性能的不断提升,铜线键合技术也逐渐显露出其局限性。
- Cu Clip键合:为了充分发挥碳化硅芯片潜在的巨大优势,Cu Clip封装技术应运而生。Cu Clip封装技术通过铜片来连接芯片与管脚,不仅具有独特的封装电阻值和更高的电流量,还具备更好的导热性能。此外,Cu Clip封装技术还能够降低高频寄生参数、提高耐温能力和绝缘强度,从而满足大功率场合下的高性能需求。
四、Cu Clip封装技术的技术特点
Cu Clip封装技术之所以能够在半导体领域崭露头角,离不开其独特的技术特点。
- 铜片连接:Cu Clip封装技术采用铜片来连接芯片与管脚,从而在一定程度上取代了标准引线键合方式。这种连接方式不仅具有独特的封装电阻值和更高的电流量,还具备更好的导热性能。
- 降低寄生参数:由于Cu Clip封装技术采用铜片进行连接,因此能够降低高频寄生参数。这对于提高功率芯片的性能和稳定性具有重要意义。
- 提高散热性能:铜片作为一种优良的导热材料,能够有效地将芯片产生的热量传递到外部环境中去。因此,Cu Clip封装技术具备更好的散热性能,有助于提升功率芯片的稳定性和可靠性。
- 灵活的形状设计:Cu Clip封装技术中的铜片可以根据实际需求进行形状设计。这种灵活性使得Cu Clip封装技术能够适应不同尺寸和形状的功率芯片封装需求。
五、Cu Clip封装技术的优势
与传统封装技术相比,Cu Clip封装技术具有显著的优势。
- 性能提升:Cu Clip封装技术通过铜片连接芯片与管脚,降低了封装电阻值和寄生参数,提高了电流量和导热性能。这些性能提升有助于提升功率芯片的整体性能和稳定性。
- 成本降低:由于Cu Clip封装技术采用铜片进行连接,因此无需像传统封装技术那样对引线脚焊接处进行镀银处理。这不仅可以节省镀银及镀银不良产生的成本费用,还可以降低整体封装成本。
- 外形一致:Cu Clip封装技术制成的产品外形与正常产品完全保持一致。这使得Cu Clip封装技术能够轻松应用于各种电子设备中,无需对原有设计进行大幅度修改。
- 应用领域广泛:Cu Clip封装技术凭借其优越的性能和成本优势,在服务器、便携式电脑、电池/驱动器、显卡、马达、电源供应等领域得到了广泛应用。
六、Cu Clip封装技术的键合方式
目前,Cu Clip封装技术主要有两种键合方式:全铜片键合方式和铜片加线键合方式。
- 全铜片键合方式:在这种键合方式中,Gate pad和Source pad均是Clip方式。这种键合方法成本较高,工艺较复杂,但能够获得更好的Rdson(导通电阻)以及更好的热效应。
- 铜片加线键合方式:在这种键合方式中,Source pad为Clip方式,而Gate为Wire方式。这种键合方式较全铜片的稍便宜,且能够节省晶圆面积(适用于Gate极小面积)。虽然工艺较全铜片简单一些,但同样能够获得更好的Rdson以及更好的热效应。
七、Cu Clip封装技术的应用案例
随着Cu Clip封装技术的不断发展和完善,越来越多的半导体企业开始采用这种封装技术来制造高性能的功率芯片。以下是一些典型的应用案例。
- 超结MOSFET:芯一代公司的超结MOSFET新品采用先进超结技术制造和Cu-Clip键合封装。这种封装结构不仅减小了成品封装体积,还提高了产品的热阻性能和电流承载能力。目前,该产品已在国内众多知名厂家的产品上批量应用,出货量已超1980万颗,销售额超2.3亿元。
- CCPAK封装方案:Nexperia公司凭借20多年使用久经考验的铜夹片技术的经验,开发出创新的CCPAK封装方案。该方案将铜夹片封装技术的所有公认优点应用于650V及更高电压应用。从汽车电气化到数据中心和5G通信高效电源等领域,CCPAK封装方案都展现出了出色的性能。
八、Cu Clip封装技术的挑战与未来发展趋势
尽管Cu Clip封装技术具有诸多优势,但在实际应用过程中仍面临一些挑战。例如,如何进一步提高Cu Clip封装技术的可靠性和稳定性、如何降低封装成本以及如何实现Cu Clip封装技术的大规模生产等。
未来,随着半导体技术的不断发展和进步,Cu Clip封装技术有望在以下几个方面实现突破和发展:
- 材料创新:通过研发新型材料来替代传统的铜片材料,进一步提高Cu Clip封装技术的性能和稳定性。
- 工艺优化:通过优化封装工艺来降低封装成本并提高生产效率。例如,采用先进的自动化设备来实现Cu Clip封装技术的大规模生产。
- 集成化趋势:随着半导体技术的不断发展,集成化趋势将愈发明显。未来,Cu Clip封装技术有望与其他封装技术相结合,形成更加高效、可靠的封装解决方案。
九、结论
Cu Clip封装技术作为一种新兴的半导体封装方式,在提升功率芯片性能、降低成本以及扩大应用领域等方面展现出了巨大的潜力。随着技术的不断发展和完善,Cu Clip封装技术有望成为未来半导体封装领域的主流技术之一。同时,我们也期待Cu Clip封装技术能够在更多领域得到广泛应用,为电子行业的持续发展注入新的活力。
-
芯片封装
+关注
关注
12文章
579浏览量
31532 -
半导体芯片
+关注
关注
61文章
934浏览量
71503 -
Clip
+关注
关注
0文章
32浏览量
7057
发布评论请先 登录

芯片,集成电路,半导体含义
芯片荒半导体封装需求激增,斯利通陶瓷封装基板供不应求
什么是 Cu clip 封装
普莱信Clip Bond封装整线设备,获功率半导体国际巨头海外工厂订单
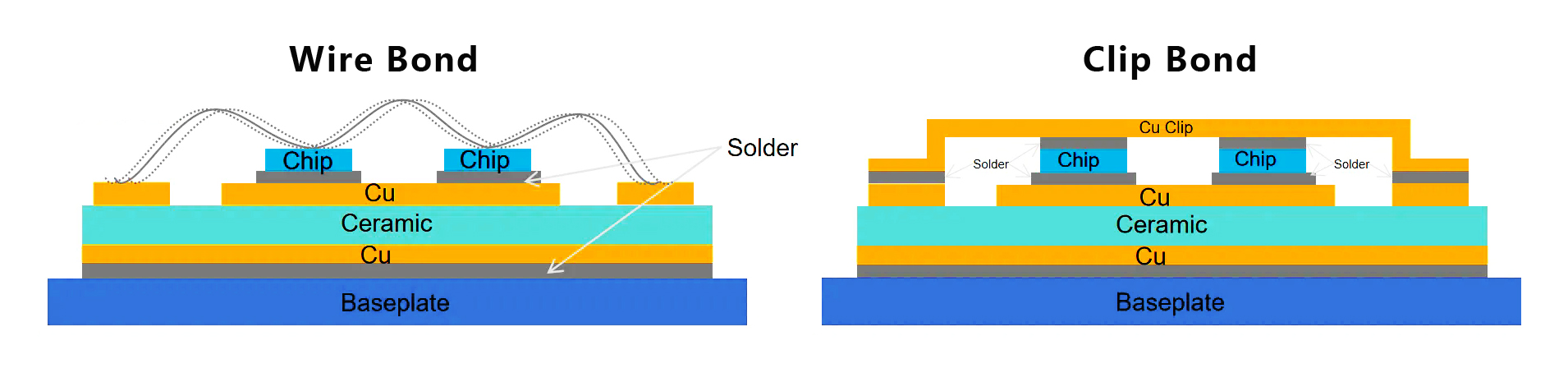





 揭秘Cu Clip封装:如何助力半导体芯片飞跃
揭秘Cu Clip封装:如何助力半导体芯片飞跃


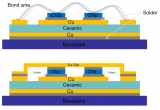
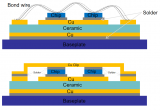













评论