本文介绍了背金工艺的工艺流程。
本文将解析一下背金工艺的具体的工艺流程及每步的工艺原理。
背金工艺的工艺流程

如上图,步骤为: tape→grinding →Si etch→ Detape→ Pre-treatment→back metal 即贴胶纸→减薄→硅刻蚀→撕胶纸→前处理→背面金属化
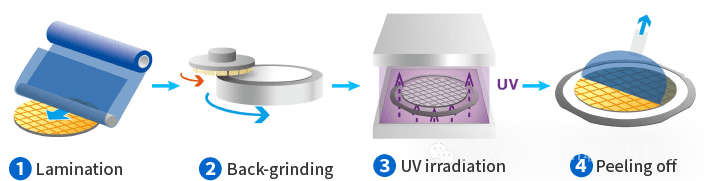
1,tape
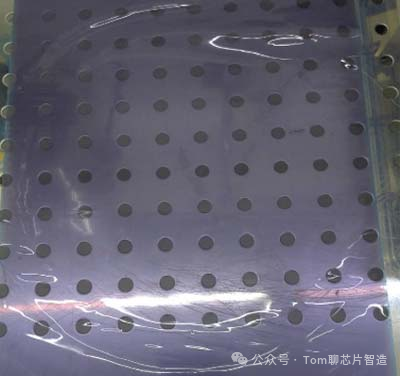
在晶圆正面贴上上图所示的蓝色胶带,保护晶圆正面的图形。 2,grinding :将硅片背面研磨,减薄到适宜厚度,采用机械抛光的方法 3,Si etch:在背面减薄之后,硅片背面会有很多缺陷,并且有硅粉残留。此时wafer内部应力很大,容易碎片,硅腐蚀可以消除其内部应力,并且使其表面粗糙度更大,金属更容易在其上淀积。

常用硝酸和氢氟酸进行刻蚀处理,方程式为: Si+HNO3+6HF=H2SiF6+H2NO2+H2O+H2 4,Pre-treatment:硅片背面的清洁度对种子层金属与Si的结合力影响很大,因此要保证足够的清洁。一般用BOE洗去硅表面的自然氧化层。

5,back metal:用电子束蒸发或磁控溅射的方法,沉积相应的金属层,以Ti/Ni/Au(Ag)为例,我曾见过的对应的金属厚度为:Ti1k?,Ni3.5k?,Au(Ag)1k?(6k?),当然厚度可以根据具体的场景而不同。 END 转载内容仅代表作者观点 不代表中国科学院半导体所立场
-
晶圆
+关注
关注
53文章
5181浏览量
130109 -
工艺
+关注
关注
4文章
690浏览量
29518
原文标题:背金工艺的工艺流程
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
详解PCB线路板多种不同工艺流程
多种电路板工艺流程
多种不同工艺的PCB流程简介
SMT贴装基本工艺流程
PCB电路板多种不同工艺流程详细介绍
pcb化学镍金工艺流程介绍
背金工艺是什么_背金工艺的作用
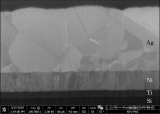





 背金工艺的工艺流程
背金工艺的工艺流程












评论