本文介绍了什么是原子层刻蚀(ALE, Atomic Layer Etching)。
1.ALE 的基本原理:逐层精准刻蚀 原子层刻蚀(ALE)是一种基于“自限性反应”的纳米加工技术,其特点是以单原子层为单位,逐步去除材料表面,从而实现高精度、均匀的刻蚀过程。它与 ALD(原子层沉积)相对,一个是逐层沉积材料,一个是逐层去除材料。
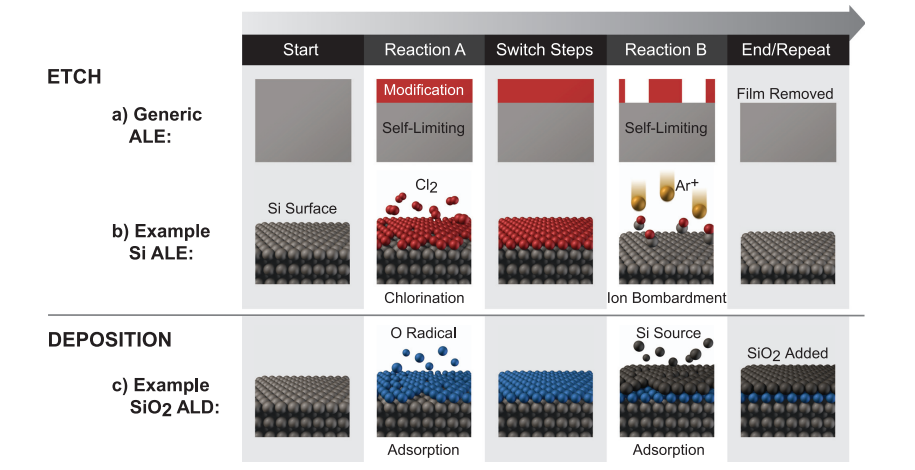
ALE 通常由以下两个关键阶段组成: 表面活化阶段:使用气相前体或等离子体激活表面,形成化学吸附层或修饰层。 例如,通过引入卤化物前体(如 Cl?、SF?),与目标材料发生化学反应,在表面生成易于刻蚀的化学物质。 物理去除阶段:通过离子轰击、加热或化学辅助,选择性去除表面已修饰的原子层,而不影响未活化区域。 去除过程严格受限于表面活性层的厚度,确保每次循环仅去除一个原子层。这种分步进行的反应和刻蚀,避免了传统刻蚀中材料过度移除或损伤的问题。
2. ALE 的主要特性与优势
2.1 原子级精度
特性:ALE 可实现单原子层单位的去除,刻蚀深度和速率均可精确控制。
原因:每一步骤都是自限性反应,刻蚀厚度由表面化学反应决定,不依赖时间或反应剂浓度。
应用:适用于 7nm、3nm 及更先进节点的半导体器件制造。
2.2 均匀性与高深宽比能力
特性:在高深宽比(Aspect Ratio, AR)的三维结构中,ALE 依然能够保持均匀刻蚀,不会出现传统技术中底部过刻或侧壁倾斜的现象。 原因:自限性反应避免了离子轰击的方向性影响,同时确保侧壁和底部刻蚀速率一致。 应用:适合 3D NAND 闪存、FinFET 晶体管等需要高纵深结构的加工。
2.3 高选择性
特性:ALE 可针对特定材料(如金属氧化物、硅化物)进行选择性刻蚀,不影响邻近的不同材料。
原因:通过优化前体化学性质,使反应仅在目标材料表面进行。
应用:适合复杂多层结构中各层材料的分离刻蚀。
2.4 损伤最小化
特性:ALE 对材料表面及基底的物理和化学损伤显著低于传统刻蚀方法。
原因:离子轰击能量较低,化学反应温和且受限于单层厚度。
应用:对热敏材料(如有机薄膜)或高精度器件(如光学镜头)的微细加工。
3. ALE 与传统刻蚀技术的对比
特性 传统刻蚀 ALE
| 刻蚀精度 | 受离子能量和刻蚀时间影响,精度较低 | 单原子层单位刻蚀,精度极高 |
| 均匀性 | 高深宽比结构中容易出现侧壁弯曲、过刻 | 均匀刻蚀,不受结构形状限制 |
| 选择性 | 难以实现高选择性 | 针对性强,可在多层结构中分离特定材料 |
| 损伤程度 | 高能量离子轰击易损伤基底 | 化学反应主导,低能量,损伤小 |
4. ALE 的工艺实现
温度控制:ALE 的反应需要一定温度激活(如 50-250°C),但温度不可过高,以免破坏材料或前体分解。
等离子体辅助:在许多 ALE 工艺中,低能量等离子体被用来增强表面反应性,同时避免传统高能离子的轰击损伤。
前体选择:根据目标材料选择合适的化学前体(如氟化物、氯化物等),确保反应的选择性和效率。
5. ALE 的主要应用
5.1 半导体制造:极紫外光刻(EUV)辅助结构:用于刻蚀图案化的极窄沟槽或高纵深结构。 FinFET 制造:实现精确的栅极与源漏区分离。5.2 光学与显示技术:图像传感器:对微透镜结构的精密加工,提升光学性能。 OLED 制备:在敏感材料上进行微结构刻蚀。 MEMS 器件:微通道与高纵深比结构的均匀刻蚀。 纳米能源与光子学:用于纳米线阵列、光学器件的高精度制造。
6. ALE 的技术挑战与未来趋势
6.1 挑战
反应速度:ALE 的分步反应导致刻蚀速率较慢,需要优化工艺以提高效率。
材料兼容性:前体的化学选择性限制了部分材料的刻蚀能力。
设备成本:ALE 工艺设备复杂,对反应室的洁净度和精密度要求高。
6.2 未来趋势
更高选择性前体开发:研究能与特定材料反应更高效的前体,提高工艺适配性。
等离子体辅助 ALE(PE-ALE):利用低能等离子体提升刻蚀速率和精度。
与 ALD 联动:结合 ALE 和 ALD 工艺,实现原子级沉积与刻蚀的动态切换,满足更复杂的器件制造需求。
7. 结论
ALE 是一种颠覆性的纳米刻蚀技术,凭借其原子级精度、高选择性、低损伤的特性,在半导体、光子学、MEMS 等领域展现出广阔的应用前景。随着前体开发和设备优化的不断进步,ALE 将在先进制程技术中扮演更加关键的角色。
-
纳米
+关注
关注
2文章
714浏览量
39349 -
ALE
+关注
关注
0文章
11浏览量
8272
原文标题:原子层刻蚀(ALE, Atomic Layer Etching)详解
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
TSV制造技术里的通孔刻蚀与绝缘层
芯片刻蚀原理是什么
半导体boe刻蚀技术介绍
原子层沉积(ALD, Atomic Layer Deposition)详解

等离子体刻蚀和湿法刻蚀有什么区别
上海伯东IBE离子束刻蚀机介绍
芯片湿法刻蚀方法有哪些
湿法刻蚀步骤有哪些
刻蚀工艺的参数有哪些

晶圆表面温度对干法刻蚀的影响






 什么是原子层刻蚀
什么是原子层刻蚀

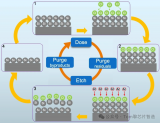
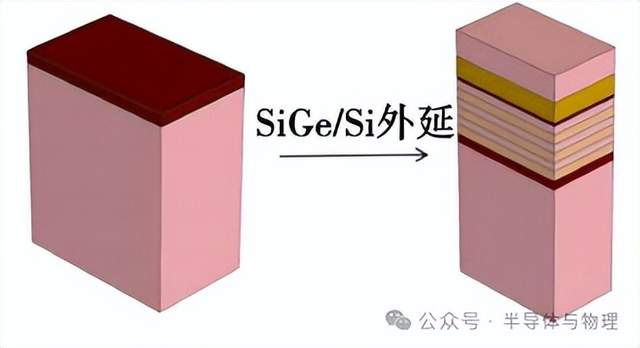

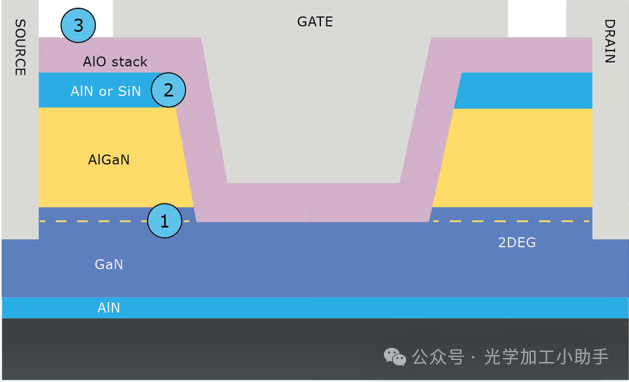










评论