来源:华天科技
在半导体封装领域,扇出(Fan-Out)技术正以其独特的优势引领着新一轮的技术革新。它通过将芯片连接到更宽广的基板上,实现了更高的I/O密度和更优秀的热性能。由于扇出型封装不需要使用昂贵的干法刻蚀设备和基板材料,具有很大的成本优势,成为各大厂家优先布局发展的战略方向。
硅基扇出封装
硅基扇出型晶圆级封装(embedded Silicon Fan-out,eSiFO)是华天科技2015年开始研发,2018年开发成功并具有自主知识产权的一种先进Fan-Out封装技术,目前已达到可以稳定作业生产量产状态。eSiFO使用硅基板为载体,通过在硅基板上干法刻蚀作出凹槽,将芯片放置且固定于凹槽内,用真空压膜填补芯片间空隙后,芯片表面和硅片表面构成了一个扇出面,在这个面上进行多层再布线,并制作引出端做球,最后切割达到封装目的。华天科技在硅基晶圆封装制造领域有着深厚的技术积累,产业下的TSV技术封装工艺路线成熟,这也是其成功研发eSiFO的关键。
eSiFO技术广泛应用于电源管理芯片、射频收发器芯片、基带处理器和高端网络系统等多种应用领域。采用eSiFO芯片Fan-out很大程度上缩小了芯片尺寸,提高晶圆产出,相比于传统封装芯片间互连更短,性能更优,在散热上也具有较明显的优势。
硅基扇出封装更深层次应用
华天科技不仅实现了单芯片硅基扇出型封装,还开发完成了多芯片的系统级集成扇出型封装并达到小批量生产,eSiFO技术可以实现多芯片系统集成SIP,易于实现芯片异质集成,相比于传统封装,整体封装尺寸大幅度缩减,芯片间互连更短,性能更强。
为了实现更高阶的微系统集成,华天科技在二维硅基扇出型封装的基础上继续开发了基于大空腔干法刻蚀、TSV直孔和临时键合技术的三维扇出型晶圆级封装(embedded System in Chip,eSinC)。该技术的一个显著优势是使用硅基取代塑封料,硅基的热膨胀系数、杨氏模量及热导率方面均优于塑封料,且因材质与芯片材质相同,散热能力更为稳定。采用TSV通孔实现垂直方向互联,大大提高了互联密度和集成度。eSinC技术的研发大大降低封装的尺寸,所获得的系统级封装产品具有易于组装、高性价比等突出优势。通过三维扇出型晶圆级封装的研发成功,使华天初步具备了下一代垂直三维互连封装技术,在后摩尔时代将发挥重要作用。
声明:本网站部分文章转载自网络,转发仅为更大范围传播。 转载文章版权归原作者所有,如有异议,请联系我们修改或删除。联系邮箱:viviz@actintl.com.hk, 电话:0755-25988573
审核编辑 黄宇
-
封装
+关注
关注
128文章
8741浏览量
145737 -
硅基
+关注
关注
0文章
61浏览量
16092
发布评论请先 登录
采用扇出晶圆级封装的柔性混合电子

聚智姑苏,共筑硅基光电子产业新篇 — “硅基光电子技术及应用”暑期学校圆满落幕!

扇出型封装材料:技术突破与市场扩张的双重奏
一种低翘曲扇出重构方案

深入解析硅基光子芯片制造流程,揭秘科技奇迹!

GaN技术:颠覆传统硅基,引领科技新纪元

玻璃基芯片先进封装技术会替代Wafer先进封装技术吗

先进封装技术-16硅桥技术(上)

盘古多芯片高密度板级扇出项目喜封金顶 年产板级封装产品8.64万板

用于单片集成的硅基外延Ⅲ-Ⅴ族量子阱和量子点激光器研究

华天南京集成电路先进封测产业基地二期项目奠基
扇出型 (Fan-Out)封装市场规模到2028 年将达到38 亿美元
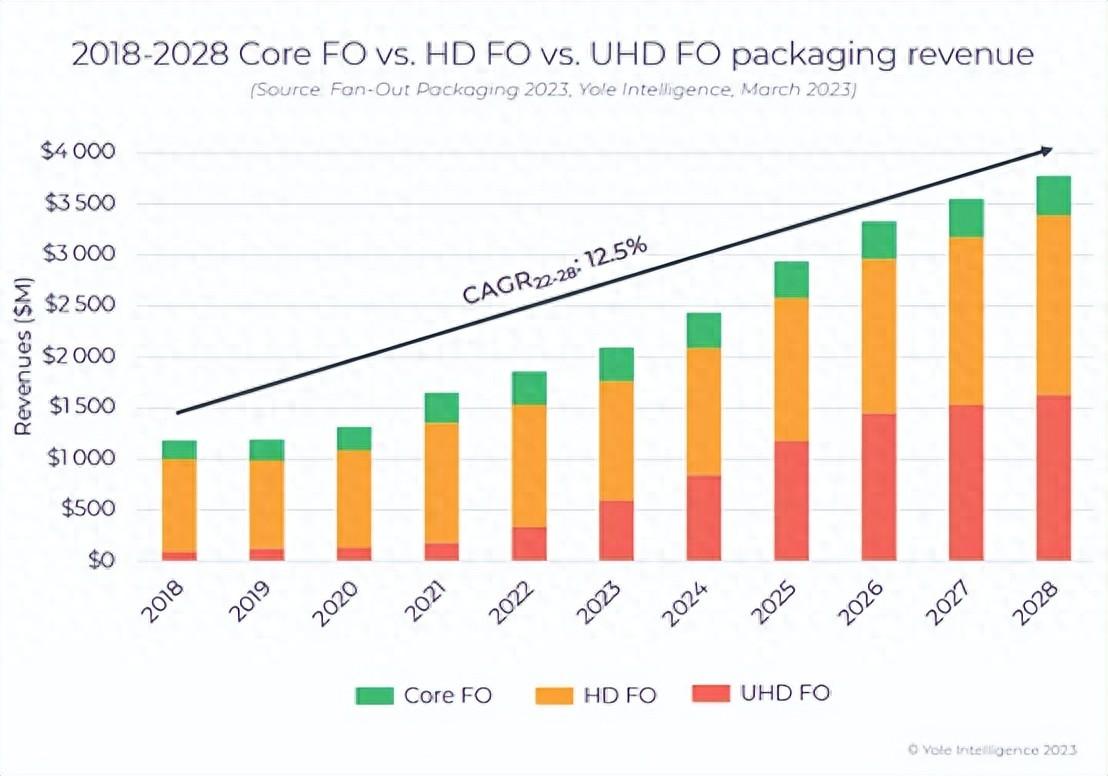





 华天科技硅基扇出封装
华天科技硅基扇出封装














评论