晶圆键合是十分重要的一步工艺,本文对其详细介绍。????????????????????????????
什么是晶圆键合胶?
晶圆键合胶(wafer bonding adhesive)是一种用于将两个晶圆永久性或临时地粘接在一起的胶黏材料。
怎么键合与解键合?
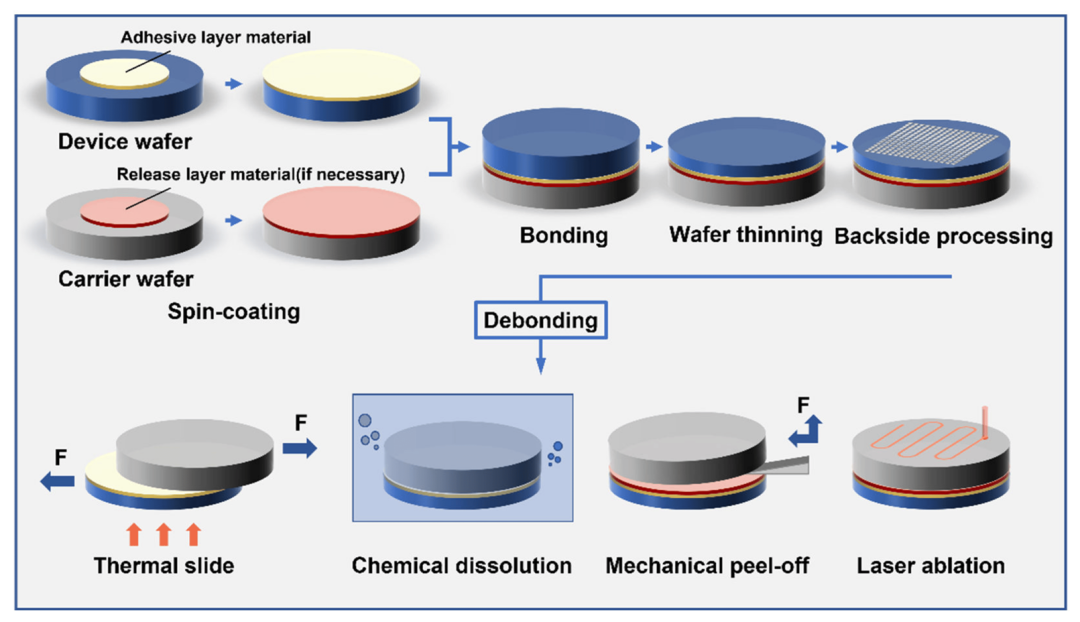
如上图,键合过程:
1.清洁和处理待键合晶圆表面。
2.将两个待键合的晶圆对准并贴合在一起。
3.施加压力和温度,促进键合胶之间的粘接。
4.继续保温,使键合材料达到最佳粘接强度。
解键合过程,有四种方案:
1,热解键合:一种是高温失去黏性,另一种是高温将键合胶融化,再施加一个平移力,使其滑动分离
2,化学药水溶解:利用化学药剂溶解键合胶
3,机械剥离,利用机械力将两片晶圆分离
4,激光解键合:用激光照射晶圆键合胶,激光能量被粘合剂材料吸收,导致局部温度急剧升高,键合胶被破坏而使两片晶圆分离。
目前,12寸的先进封装厂,用激光解键合的方式较为普遍。
-
激光
+关注
关注
20文章
3475浏览量
67558 -
晶圆
+关注
关注
53文章
5181浏览量
130126
原文标题:晶圆键合胶如何进行键合与解键合的?
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
什么是引线键合?芯片引线键合保护胶用什么比较好?

面向临时键合/解键TBDB的ERS光子解键合技术
铜线键合IMC生长分析

什么是引线键合(WireBonding)

电子封装 | Die Bonding 芯片键合的主要方法和工艺






 晶圆键合胶的键合与解键合方式
晶圆键合胶的键合与解键合方式



















评论