AMD的Instinct MI300X以及英伟达的B200 GPU是否属于巨型产品?据报道,台积电在最近的北美技术研讨会上透露其正在研发新的CoWoS封装技术,进一步扩大SiP的体积和功耗。知情人士称,新封装将采用超大规模的120x120毫米设计,功耗预计高达数千瓦。
新版CoWoS技术使得台积电能制造出面积超过光掩模(858平方毫米)约3.3倍的硅中介层。因此,逻辑电路、8个HBM3/HBM3E内存堆栈、I/O及其他小芯片最多可占据2831平方毫米的空间。而最大基板尺寸则为80×80毫米。值得注意的是,AMD的Instinct MI300X和英伟达的B200均采用了这项技术,虽然英伟达的B200芯片体积大于AMD的MI300X。
预计2026年推出的CoWoS_L将能实现中介层面积接近光罩尺寸的5.5倍(虽不及去年宣布的6倍,但仍属惊人之举)。这意味着4719平方毫米的空间可供逻辑电路、最多12个HBM内存堆栈及其他小芯片使用。然而,由于这类SiP所需基板较大,台积电正考虑采用100x100毫米的设计。因此,这类芯片将无法兼容OAM模块。
此外,台积电表示,至2027年,他们将拥有一项新的CoWoS技术,该技术将使中介层面积达到光罩尺寸的8倍甚至更高,从而为Chiplet提供6864平方毫米的空间。台积电设想的一种设计方案包括四个堆叠式集成系统芯片 (SoIC),搭配12个HBM4内存堆栈和额外的I/O芯片。如此庞大的设备无疑将消耗大量电力,且需配备先进的散热技术。台积电预计此类解决方案将采用120x120毫米的基板。
值得一提的是,今年早些时候,博通展示了一款定制AI芯片,包含两个逻辑芯片和12个HBM内存堆栈。尽管我们尚未得知该产品的详细规格,但从外观上看,它似乎比AMD的Instinct MI300X和英伟达的B200更为庞大,尽管尚未达到台积电2027年计划的水平。
-
逻辑电路
+关注
关注
13文章
502浏览量
43403 -
台积电
+关注
关注
44文章
5760浏览量
170150 -
CoWoS
+关注
关注
0文章
154浏览量
11126
发布评论请先 登录
台积电扩大先进封装设施,南科等地将增建新厂
台积电超大版CoWoS封装技术:重塑高性能计算与AI芯片架构
台积电先进封装大扩产,CoWoS制程成扩充主力
台积电CoWoS封装A1技术介绍

台积电计划2027年推出超大版CoWoS封装
台积电CoWoS产能将提升4倍
台积电封装,新规划
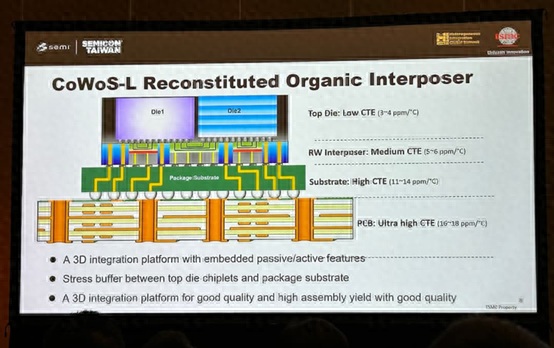





 台积电新版CoWoS封装技术拓宽系统级封装尺寸
台积电新版CoWoS封装技术拓宽系统级封装尺寸












评论