集微网消息,汽车电子是时下芯片行业为数不多的增量市场,且有望接替智能手机,成为下一波芯片行业发展浪潮的主要推动力。
传统汽车向智能电动汽车的转型需经历“新四化”的变革过程,即电动化、智能化、联网化和共享化。“新四化”正促使单车的芯片用量和成本大幅上升,传统汽车单台芯片成本约300美元,而电动汽车的单台芯片成本为600美元,L3及以上级别的单台芯片成本则超过1000美元,部分达2000美元以上。
汽车芯片市场不断增长的同时,“新四化”也对汽车芯片本身提出了更高要求,例如主控芯片需要更高的算力,功率器件和MCU需要更低功耗和更高可靠性等。为满足这些要求,先进封装技术正成为汽车芯片的主流选择。
另一种先进
提及先进封装,台积电的CoWoS和InFO、三星的X-Cube以及英特尔的EMIB等晶圆级封装是如今最为人所熟知的方案。在Chiplet热潮的带动下,这些晶圆级封装技术扶持着逼近极限的摩尔定律继续向前,巨大的市场机遇面前,传统的封测厂商也开始钻研晶圆级技术,意图分一杯羹。
然而,所谓的先进封装技术是指某个时期的技术体系革新,不应仅仅局限于高端芯片和先进工艺节点的应用。如果晶圆级封装用来“瞻前”,那么也需要有另一种先进封装技术用来“故后”。在近期刚刚结束的Semicon China 2023上,Manz集团(亚智科技)带来的FOPLP整厂解决方案,或许正是先进封装技术“故后”的最佳选择之一。
Manz集团亚洲区研发部协理李裕正博士在接受集微网采访时,便以汽车芯片为例提到了传统封装技术所面临的问题,和板级封装技术带来的机遇。
一台智能电动汽车可能需要用到1000~2000颗芯片,其中大部分芯片都是电源控制、IGBT和MOSFET等电源类器件。汽车上的电源类器件过去通常采用wire bond(打线)的封装方式,但近年来这种传统技术正逐渐面临瓶颈,汽车芯片厂正寻求新的先进封装技术以缩短线路路径,增强线路导电性等。因此,FC、BGA、板级Fan-out和晶圆级Fan-out等技术开始进入汽车芯片厂商的视野。
不过,随着整车厂在价格上的内卷越来越严重,汽车芯片厂也不得不顺应趋势,对成本控制也开始越发严苛。李博士表示,在FC、BGA、板级Fan-out(FOPLP)和晶圆级Fan-out(FOWLP)中,板级Fan-out封装相比FC、BGA以及晶圆级Fan-out封装都有着不同程度的成本优势,甚至比传统的QFN封装方案还要低20%,因此在汽车芯片从传统封装切换至先进封装方案时,板级Fan-out技术有望捕获更多的市场机会。
目前,Fan-out封装在整个先进封装的市场规模中所占份额仅有10%,板级方案又仅占整个Fan-out市场的10%,未来还拥有巨大的增长空间。
如何渗透
板级Fan-out封装的市场成长性是可以预见的,但如何才能快速渗透需要Manz集团等参与者共同考虑。在李博士看来,推动板级Fan-out技术发展既需要选择对方向,又要努力做好技术产品的打磨。同时,选择比努力更重要。
作为推动板级Fan-out封装发展主要力量,Manz集团既要努力保持技术和产品的领先,也要选择最优的目标客户和市场。在晶圆级封装拥有得天独厚优势的晶圆代工厂对板级封装无感,传统封测厂也仅对承接外溢的晶圆级封装需求有兴趣,因此这两类客户都不会是板级Fan-out技术的主要玩家。而得益于汽车上的大量电源类芯片对板级Fan-out封装的现实需求,李博士认为,汽车芯片客户将是Manz集团推动该技术渗透的最佳选择。
随着汽车芯片市场竞争愈发激烈,汽车芯片IDM厂商越来越期待利用板级Fan-out封装技术提升产品性能,降低产品成本。而且这些公司本身大多数都有自己的封测厂,无论从决策层面还是工艺整合层面,板级Fan-out技术都更容易在这一类客户中渗透开来。
除了传统的汽车芯片大厂,近年来新能源汽车的火热也催生了一大批第三代半导体厂商,李博士强调,这些公司也都是推动板级Fan-out技术渗透的潜在目标,另外还有系统集成度越来越高的射频芯片公司等。
选择好目标方向,板级Fan-out封装的渗透速度和质量还需要取决于封装设备和技术的打磨。晶圆级Fan-out封装拥有标准化尺寸,因此设备和材料都趋于成熟。反观板级Fan-out封装,其基板的材质和尺寸的多样化也给封装设备和全流程技术方案带来了更大的挑战。
李博士进一步表示,通常而言,板级Fan-out封装的设备都是基于客户需求来做定制化,所以设备供应商需要具备提供全流程解决方案的能力。基于多年积累,Manz集团的一站式完整服务就不仅能提供制程技术开发以及设备制造,还涵盖以自动化整合上下游设备整场生设备线,协助客户生产设备调试乃至量产以后的售后服务规划。
凭借长久在湿法化学制程、电镀、自动化、量测与检测等制程解决方案应用于不同领域所累积的核心技术,不久前Manz集团便打造出了业界第一条700×700mm生产面积的FOPLP封装技术RDL生产线,该方案在RDL导线层良率与整体面积利用率方面展现出了强大的竞争优势,大幅降低了封装制程的成本。
据介绍,Manz电镀设备能够实现整面电镀铜的均匀性高达92%,镀铜厚度也能做到100μm以上规格,在提升封装密度和降低封装厚度的同时,实现更优良的导电性和散热性。
目前,Manz集团基于已经与国际IDM大厂合作组装了一条验证生产线,正紧锣密鼓的准备迎接未来陆续的量产订单。
“展望未来,Manz集团将与客户一同推动板级Fan-out封装加速渗透,扩大规模量产与成本的优势,加速FOPLP市场化与商业化的快速成长,以此打造半导体新应用的发展契机,”李博士如是说。
-
mcu
+关注
关注
146文章
18031浏览量
369306 -
功率器件
+关注
关注
42文章
1947浏览量
92994 -
汽车芯片
+关注
关注
10文章
940浏览量
44242 -
先进封装
+关注
关注
2文章
479浏览量
667
原文标题:电车时代,汽车芯片需要的另一种先进封装
文章出处:【微信号:汽车半导体情报局,微信公众号:汽车半导体情报局】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
突破!华为先进封装技术揭开神秘面纱

自动驾驶“电车难题”如何解?
一种新型RDL PoP扇出晶圆级封装工艺芯片到晶圆键合技术










 电车时代,汽车芯片需要的另一种先进封装
电车时代,汽车芯片需要的另一种先进封装




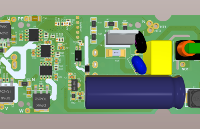











评论