音响控制板BGA芯片加固保护用胶底部填充胶应用由汉思新材料提供
客户是网络产品生产商.重点为客户提供OEM/ODM服务给各类客户定制与公板近100款,部分产品已经在WIFI音箱/商业WIFI/探针/移动电源与存储/物连网IOT/行车记录仪/运动DV/MID/安防等领域.其中WIFI音箱用到汉思新材料的底部填充胶水.
客户产品为音响控制板
用胶产品部位:音响控制板BGA芯片要点胶保护.
客户需要解决的问题:
客户产品做跌落测试时功能不良,原因为做跌落测试后BGA芯片脱焊。
芯片尺寸大小:有两个BGA芯片,
尺寸分别为:11*11mm,球径0.5,间距0.65,锡球数284;13*7.5mm,球径0.5,锡球数96。
客户对胶水及测试要求:
1,固化温度150度以下.
2,做跌落测试,产品在2米高跌落后功能正常.
汉思新材料推荐用胶:
推荐HS706和HS710底部填充胶给客户.
已约客户带上样品到客户工厂试样.
客户对试样结果比较满意.采用了汉思底填胶进行批量生产.
-
芯片
+关注
关注
460文章
52616浏览量
442690 -
音响
+关注
关注
59文章
552浏览量
57683 -
BGA封装
+关注
关注
4文章
121浏览量
18727
发布评论请先 登录
汉思新材料:车规级芯片底部填充胶守护你的智能汽车

先进封装Underfill工艺中的四种常用的填充胶CUF,NUF,WLUF和MUF介绍

芯片封装胶underfill底部填充胶点胶工艺基本操作流程






 音响控制板BGA芯片加固保护用胶底部填充胶应用
音响控制板BGA芯片加固保护用胶底部填充胶应用





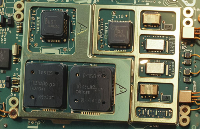

















评论