在Intel的六大技术支柱中,封装技术和制程工艺并列,是基础中的基础,这两年Intel也不断展示自己的各种先进封装技术,包括Foveros、Co-EMIB、ODI、MDIO等等。
今天,Intel又宣布了全新的“混合结合”(Hybrid Bonding),可取代当今大多数封装技术中使用的“热压结合”(thermocompression bonding)。

据介绍,混合结合技术能够加速实现10微米及以下的凸点间距(Pitch),提供更高的互连密度、更小更简单的电路、更大的带宽、更低的电容、更低的功耗(每比特不到0.05皮焦耳)。
Intel目前的3D Foveros立体封装技术,可以实现50微米左右的凸点间距,每平方毫米集成大约400个凸点,而应用新的混合结合技术,不但凸点间距能缩小到1/5,每平方毫米的凸点数量也能超过1万,增加足足25倍。
采用混合结合封装技术的测试芯片已在2020年第二季度流片,但是Intel没有披露未来会在什么产品上商用。
-
芯片
+关注
关注
460文章
52624浏览量
442815 -
英特尔
+关注
关注
61文章
10205浏览量
175116 -
封装
+关注
关注
128文章
8743浏览量
145753
发布评论请先 登录
英特尔宣布工程技术领导层重要任命,加速CEO陈立武转型布局
英特尔先进封装,新突破
英特尔宣布裁员20% 或2万人失业
英特尔推出全新英特尔锐炫B系列显卡

英特尔发布全新企业AI一体化方案
英特尔CEO Gelsinger宣布退休
英特尔扩容成都封装测试基地
英特尔扩容在成都的封装测试基地
英特尔至强品牌新战略发布
浅谈英特尔在先进封装领域的探索
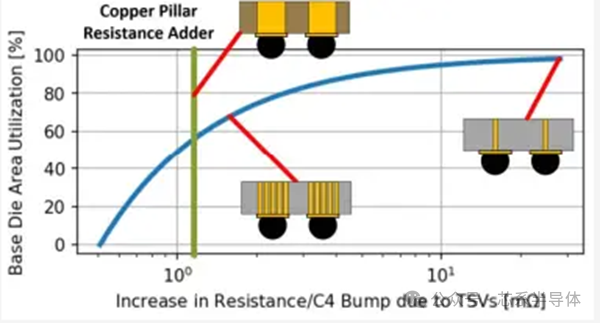





 英特尔宣布混合结合封装技术,可替代“热压结合”
英特尔宣布混合结合封装技术,可替代“热压结合”


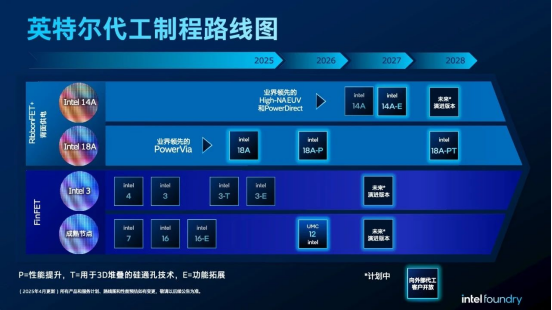











评论